Методы локализации анализа отказов в микроэлектронике
В помощь технологуВ предыдущем выпуске новостной рассылки мы рассказали о том, как исследовать внутренние дефекты микросхем без вскрытия чипа.
В сегодняшней статье речь пойдет об электронно-ионных методах анализа отказа.
Анализ отказов – это исследование характера и механизма отказа с использованием оптических, электрических, физических и химических методик анализа
Отказавшее устройство сначала подвергается визуальному осмотру корпуса (входной контроль) для проверки электрических характеристик. Если отказ подтверждается, то вскрывается корпус (производится декапсуляция) и чип анализируется согласно характеру отказа.
В зависимости от типа дефекта применяются различные методы локализации, которые можно классифицировать по следующим типам:
2. Зондовые и атомно-силовые.
3. Оптические.
Электронно- и ионно-лучевые методы анализа отказов
- Сканирующая (растровая) электронная микроскопия - SEM, Scanning Electron Microscopy;
- Фокусированный ионный пучок (ионная микроскопия) - FIB, Focused Ion Beam;
- Сканирующая просвечивающая (трансмиссионная) электронная микроскопия - STEM, Scanning transmission electron microscope;
- Просвечивающая (трансмиссионная) электронная микроскопия – TEM, Transmission Electron Microscopy;
- Энерго-дисперсионая рентгеновская спектроскопия (микроанализ) – EDX, Energy-dispersive X-ray spectroscopy (EDS, EDX, EDXS or XEDS) energy dispersive X-ray analysis (EDXA) or energy dispersive X-ray microanalysis (EDXMA);
- Спектроскопия потери энергии электронами – EELS, Electron Energy Loss Spectroscopy;
- Измерение тока, индуцированного электронным лучом – EBT, Electron Beam Testing.
Краткое описание электронно-ионных методов
SEM
Scanning Electron Microscope (SEM) - растровая/сканирующая электронная микроскопия. При этом методе микроскоп сканирует исследуемый образец электронным лучом и измеряет интенсивность квантов, испускаемых образцом. Измеренная интенсивность преобразуется в электрический сигнал. Принцип работы СЭМ/РЭМ следующий: электроны, испускаемые электронной пушкой ускоряются до энергии 2-40 кэВ; набор магнитных линз и отклоняющих катушек сканирования формирует электронный пучок малого диаметра, разворачиваемый в растр на поверхности образца. При облучении этой поверхности электронами возбуждаются три типа излучения: отраженные или обратно-рассеянные электроны, вторичные электроны, рентгеновские лучи.
По сравнению с оптическими микроскопами характеризуется более высокими пространственным разрешением и глубиной резкости, а также возможностью проведения химического анализа на основе регистрации спектра излучения, генерируемого при облучении поверхности образца электронным пучком. SEM подходит для определения геометрических характеристик анализируемых объектов - резкость границ топологических рисунков, расстояние между элементами микрообъектов, степень рассовмещения и т.д.
EBSD
Метод EBSD – представляет собой метод микроструктурно- кристаллографической характеристики для изучения любого кристаллического или поликристаллического материала. Этот метод предполагает понимание структуры, ориентации кристаллов и фазы материалов в сканирующем электронном микроскопе (SEM). Обычно он используется для изучения микроструктур, выявления текстуры, дефектов, морфологии и деформации. Его можно комбинировать с дополнительными методами в рамках SEM. В итоге анализируются дифракционная картина (линии Кикучи), обусловленная увеличением количества отраженных электронов на кристаллической поверхности решетки.
Рис.1.Дифракционная картина электронно - обратного рассеяния монокристаллического кремния, взятая на 20 кВ с полевым источником электронов
FIB
Широко используемая методика в материаловедении для локального анализа, напыления и травления материалов. Установка для ионного травления напоминает растровый электронный микроскоп. В электронном микроскопе используется пучок электронов, тогда как в FIB применяют более тяжелые частицы — ионы (с большей кинетической энергией). Этот метод вытравливает определенную область на чипе, испуская тонкий сфокусированный ионный пучок на поверхность чипа, чтобы вызвать эффект распыления.
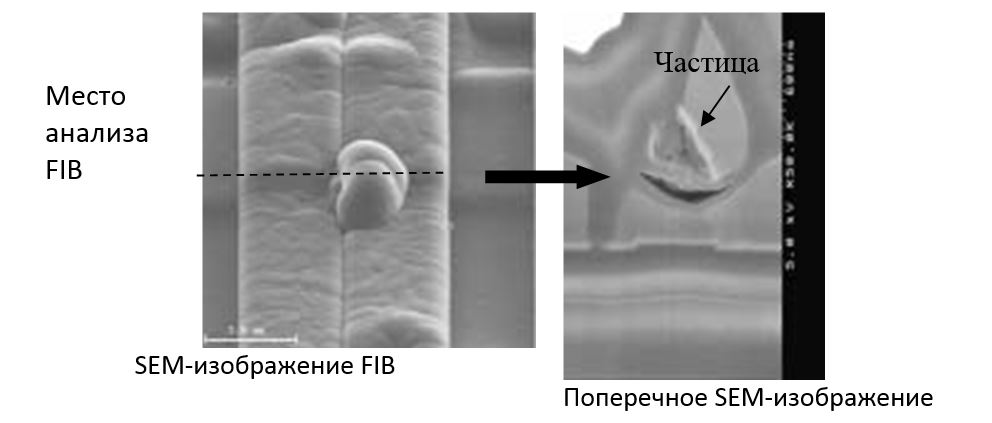
Рис.2 Наблюдение SEM поперечного сечения чипа после применения FIB
STEM
Сканирующий просвечивающий электронный микроскоп представляет собой тип просвечивающего электронного микроскопа (TEM), изображения на котором формируются электронами, проходящими через достаточно тонкий образец. Однако, в отличие от TEM, в STEM электронный луч фокусируется на мелкое пятно, которое затем сканируется по образцу в растре. Растрирование пучка по образцу делает STEM подходящим для аналитических методов, таких как Z-контрастное кольцевое изображение в темном поле, и спектроскопическое картирование с помощью спектроскопии с EDX или EELS. Эти сигналы могут быть получены одновременно, что обеспечивает прямую корреляцию изображений и спектроскопических данных.
TEM
TEM – просвечивающий электронный микроскоп, который испускает поток электронов, ускоренный благодаря высокому напряжению, и обнаруживает электроны, прошедшие через образец. Этот метод имеет очень высокую пространственную разрешающую способность (0,2 нм при 200 кэВ). Однако толщина образца должна быть порядка 0,1 мкм или менее. Высокое качество образцов будет при толщине сравнимой со средней длиной свободного пробега электронов в образце, которая может быть всего несколько десятков нанометров.
Рис.3 Подготовка образца с помощью FIB, для дальнейшей работы с TEM
EDX
Энергетический дисперсионный рентгеновский анализ (EDX), называемый EDS или EDAX, представляет собой рентгеновский метод, используемый для идентификации элементарного состава материалов. Приложения включают материалы и исследования продуктов, устранение неисправностей и деформацию.
Рис.4 Отображение элементов, поиск дефектных включений.
EELS
Спектроскопия характеристических потерь энергии электронами — разновидность электронной спектроскопии, в которой исследуемая материя подвергается облучению электронами с узким диапазоном энергий, и изучаются потери энергии неупруго рассеянных электронов. EELS позволяет локально быстро и достаточно точно измерять толщину образца в TEM.
На рис.5 представлен пример применения метода EELS. EELS показывает степень окисления Ce. Ce меняет валентность от Ce4+ до Ce3+ из объема к поверхности из-за недостатков кислорода.
Рис. 5. CeO2-x, разрешение 0,25 эВ при 120кВ
EBIC
Метод тока, наведенного электронным лучом (EBIC – Electron Beam Induced by Current) широко распространен в крупных иностранных компаниях. Метод EBIC может использоваться для исследования электрофизических свойств полупроводников и приборов микроэлектроники. Позволяет определить области локальных дефектов, а также узнать параметры и местоположение p-n переходов.
Рис.6.Электрические и оптические характеристики на поверхности пассивации в наноструктурах GaAs. На графике зависимость PL-интенсивности от времени (metal electrode – металлический электрод, unpassivated – непассивированных, passivated –пассивированных, undoped – нелигированных, n-doped – n-лигированных)
Рис. 7. EBIC в поперечном сечении образцов с «мертвыми» (dead wires) и электрически активными (active wires) нанопроволоками SiNW
EBT
При этом методе на поверхность чипа испускается тонкий сфокусированный электронный луч диаметром приблизительно 0,1 мкм, в то время как устройство работает с тестером БИС или ему подобным, чтобы измерить распределение напряжений и форму волны внутренних проводников (рис.8). Так как метод бесконтактен, его проще использовать по сравнению с обычными методами исследования, он позволяет проводить измерения при высоком импедансе (без нагрузки), что особенно подходит для измерения сигналов синхронизации с высокой точностью (диапазон частот до 7 ГГц).
Данный метод позволяет проследить проводники (узлы) и определить место отказа, используются несколько методик, включая сравнение распределения потенциалов для дефектных и недефектных устройств и сравнение измеренных и логически смоделированных сигналов.
Рис. 8. Распределение потенциала EBT: белый – отрицательный потенциал; черный – положительный потенциал
Рис. 9. Форма волны напряжения EBT
<Рис. 8. CAD-инструмент навигации
Если Вам необходимо получить более подробную информацию о методах локализации для анализа отказов в микроэлектронике, обращайтесь в нашу компанию. Наши специалисты расскажут подробно о методах анализа отказов и подберут для Вас соответствующее оборудование. Присылайте свои вопросы на электронную почту: info@sernia.ru.