Проблемы пробоподготовки микроэлектронных устройств
Основные трудности при послойном удалении материала при поиске отказов заключается в том, что необходимо качественно и без артефактов выполнить удаление сверхтонких слоев, имеющих различные химические и физические свойства, и, помимо этого, обеспечить возможность исследования одновременно нескольких слоев.
Процесс совершенствования микроэлектронных устройств – это непрерывное усложнение их структуры, уменьшение размеров и увеличение плотности компоновки элементов. Значительно усложнилась процедура последовательного удаления топологических слоев микроэлектронного устройства при поиске отказов и контроле качества изготовления микросхем. Применение комбинированного подхода с использованием нескольких из указанных ниже методов позволяет обнаружить полный спектр физических дефектов микроэлектронных устройств (в случае их наличия).
Комбинированный метод пробоподготовки от Fischione Instruments
Основная потребность современного анализа отказов – это комбинация точных, быстрых и относительно простых методов послойного удаления материала и изготовления поперечных сечений устройств, размещенных на полупроводниковых пластинах различных размеров.
Для решения этих задач предлагается комбинированный метод пробоподготовки:
-
применение низкоэнергетического расфокусированного пучка ионов аргона для удаления материалов с помощью 1063 WaferMill™ Fischione Instruments ;
-
создание поперечных сечений микроэлектронных устройств с помощью 1061 SEM Mill Fischione Instruments.
Для проверки эффективности использования такого комбинированного метода мы рассмотрим 2 экспериментальных исследования. В качестве образцов для экспериментов были выбраны два популярных и доступных устройства: память, построенная по технологии 3D сборки (Samsung 3D V-NAND) и твердотельный накопитель (SSD) с воздушными зазорами компании Intel. Данные изделия были выбраны по причине сложности их внутренней структуры, позволяющей наиболее полно продемонстрировать возможности применения расфокусированного ионного пучка.
Образец №1 - память Samsung 3D V-NAND
Изготовление поперечного сечения образца
Поперечное сечение образца было изготовлено с помощью установки 1061 SEM Mill Fischione Instruments. Предварительно было выполнено грубое сечение образца методом раскалывания, после чего устройство размещено на защитной маске посредством специального приспособления для загрузки образцов от Fischione Instruments, которое позволяет позиционировать маску с точностью до 10 мкм. Затем поперечный скол образца был подвергнут обработке одиночным ионным пучком аргона. При этом использовались следующие параметры обработки: ускоряющее напряжение ионного пучка 5 кВ, угол наклона пучка 0° и максимальный угол качания столика образцов 20°.
Планарное удаление слоев материала
Последовательное послойное удаление слоев 3D Flash-памяти V-NAND было выполнено с помощью установки 1063 WaferMill™ Fischione Instruments, изначально предназначенной для подготовки образцов к сверхточным измерениям методом CD-SEM, однако впоследствии неплохо себя зарекомендовавшей при решении задач планарного удаления слоев для образцов микроэлектроники. В эксперименте использовалась система в конфигурации, позволяющей проводить обработку пластин 300 мм.
Быстрое и равномерное ионно-лучевое травление достигается за счет трех источников ионов аргона, расположенных на виртуальной окружности таким образом, что градусная мера дуги между ними равна 120°. Ускоряющее напряжение ионного пучка может варьироваться от 0,1 В до 10 кВ. Наклон пучка настраивается в диапазоне от 22,5° до 32,5°. Послойное препарирование образца Flash-памяти осуществлялось при энергии ионов пучка 4 кэВ и угле наклона пучка 22,5°. Общая продолжительность последовательного удаления всех топологических слоев составила 50 минут.
По причине сложного строения образца и наличия в его составе большого количества изготовленных из различных материалов слоев, контроль результатов послойного травления был осуществлен не путем оценки скорости удаления материалов, а визуально, с помощью сканирующего электронного микроскопа (СЭМ) с источником полевой эмиссии и системы энергодисперсионного микроанализа (ЭДС). Для этого ионная обработка осуществлялась этапами по 2 минуты, по окончании каждого из которых производилась регистрация изображений и выполнялся сбор данных микроанализа.
Анализ полученного поперечного сечения
Одной из распространенных задач изготовления поперечных сечений является получение информации о внутренней структуре образцов с целью определения стратегии планарного травления. При отсутствии такой информации гарантировать успешный результат послойного травления довольно затруднительно.
Изображения поперечных сечений 3D Flash-памяти V-NAND, выполненных пучком ионов аргона с энергией 5 кэВ, приведены на рисунке 1. Анализ элементного состава методом ЭДС позволил идентифицировать материалы всех слоев, обнаруженных на поперечных сечениях. Топологические слои исследуемого образца указаны в таблице 1.
Таблица 1 – Слои, обнаруженные при анализе поперечного сечения 3D памяти V-NAND
|
Обозначение слоя на рисунке 1 |
Материал слоя и назначение |
|
a |
Защитный слой Si3N4 |
|
b |
Слой пассивации SiO2 |
|
c |
Верхний диффузионный барьер TiN |
|
d |
Слой металлизации Al |
|
e |
Нижний диффузионный барьер TiN |
|
f |
Линия бит Cu |
|
g |
Сигнальная линия W |
|
h |
Стержни из W с кольцевыми изоляторами Si3N4 |
|
i |
Вертикальные общие контакты W |
|
j |
Канал 3D памяти |
|
k |
Канал 3D памяти |
|
l |
Канал 3D памяти |
|
m |
Канал 3D памяти |
|
n |
Канал 3D памяти |
|
o |
Канал 3D памяти |
|
p |
Канал 3D памяти |
|
q |
Канал 3D памяти |
|
r |
Нижний слой (нижняя часть общих контактов W) |
Результаты планарного травления устройства
В верхней части 3D Flash-памяти V-NAND располагается защитный слой Si3N4 (обозначен буквой «а» на рисунках 1 и 2). Под ним находится слой пассивации SiO2, который на рисунке 2 выглядит более темным по сравнению с верхним слоем. Слой металлизации Al на рисунках 1 и 2 обозначен буквой d. Сверху и снизу проводников этого слоя располагаются диффузионные барьеры TiN (на рисунках 1 и 2 обозначены буквами c и e соответственно). Ниже слоя металлизации находятся структуры, отвечающие за формирование массива памяти. Линия бит Cu соединяется с сигнальной линией W (буквы f и g на рисунках 1 и 2). Под сигнальной линией W можно увидеть соединительные стержни (буква h на рисунках 1 и 2).
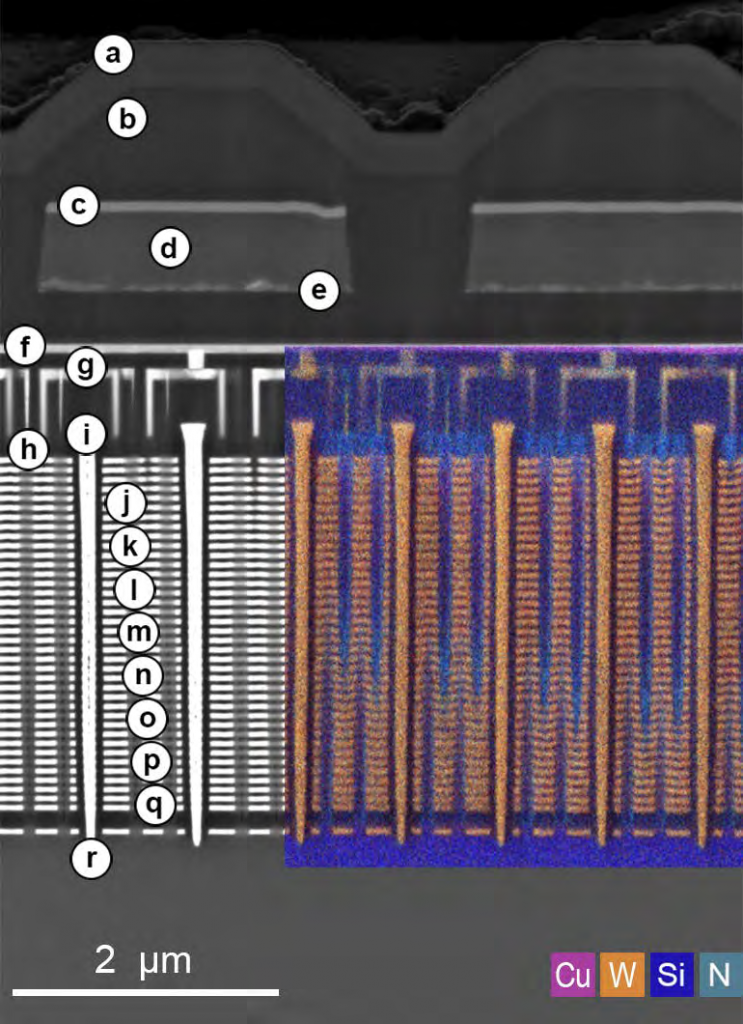
Рисунок 1 – Изображение поперечного сечения 3D Flash-памяти V-NAND,
изготовленного ионно-лучевым травлением при ускоряющем напряжении ионов аргона 5 кэВ,
совмещенное с результатами картирования химических элементов методом ЭДС при 3 кэВ.
Буквенные обозначения слоев соответствуют аналогичным обозначениям на рисунке 2.

Рисунок 2 – Изображения топологических слоев, полученные с помощью СЭМ
с источником полевой эмиссии в ходе планарного препарирования 3D Flash-памяти V-NAND
прибором для пробоподготовки к сверхточным измерениям методом CD-SEM
Образец №2 - твердотельный накопитель SSD Intel
Изготовление поперечного сечения образца
Поперечные сечения данного образца были выполнены по схеме, приведенной в описании эксперимента 1.
Планарное травление образца
Послойное травление накопителя SSD было выполнено с помощью системы ионно-лучевого травления 1061 SEM Mill Fischione Instruments, представляющей собой компактную настольную установку, предназначенную для обработки одновременно нескольких образцов. Данная установка оснащена двумя источниками ионов аргона. Энергия ионов варьируется в пределах от 0,1 эВ до 10 кэВ, угол наклона пучка – от 0° до 10°. В камере установки можно разместить образец с максимальными размерами 32 мм х 25 мм. Послойное препарирование накопителя SSD выполнялось при ускоряющем напряжении ионного пучка 5 кВ, угле падения пучка 3° и непрерывном вращении столика образцов на 360°.
Аналогично эксперименту 1, контроль результатов послойного травления был осуществлен визуально, с помощью сканирующего электронного микроскопа (СЭМ) с источником полевой эмиссии и системы энергодисперсионного микроанализа (ЭДС).
Анализ полученных поперечных сечений
Таблица 2 – Слои, обнаруженные при анализе поперечного сечения накопителя SSD с воздушными зазорами
|
Обозначение слоя на рисунке 2 |
Материал слоя и его толщина |
|
a |
Si3N4: 800 нм |
|
b |
SiO2: 1000 нм |
|
c |
TiN: 50 нм |
|
d |
Al: 700 нм |
|
e |
TiN: 100 нм |
|
f |
SiO2: 500 нм |
|
g |
Cu: 200 нм |
|
h |
W: 50 нм |
|
i |
Верхняя часть контактов из W: 450 нм |
|
j |
SiO2: 250 нм |
|
k |
Si3N4: 80 нм |
|
l |
W: 80 нм |
|
m |
Нижняя часть контактов из W: 450 нм |
Результаты планарного травления
В верхней части накопителя SSD с воздушными зазорами располагается защитный слой Si3N4 (обозначен буквой «а» на рисунке 3). Под ним находится слой SiO2, обозначенный буквой b на рисунках 3 и 4. Он выглядит более темным по сравнению с защитным слоем. Слой металлизации Al на рисунках 2 и 4 обозначен буквой d. Сверху и снизу проводников этого слоя располагаются диффузионные барьеры TiN (на рисунке 3 обозначены буквами c и e соответственно). На рисунке 4 буквой f отмечен слой, содержащий дорожки Cu и переходные контакты W в диэлектрике SiO2. Данный слой на изображении поперечного сечения также обозначен буквой f. Ниже находятся проводники Cu (буква g на рисунках 3 и 4). Затем можно увидеть вольфрамовую линию (буква h на рисунках 3 и 4), соединенную с вертикальными контактами из W (буквы i, m на рисунках 3 и 4). Воздушные зазоры образованы двумя слоями: слой из Si3N4 (буква k на рисунках 3 и 4) расположен сверху зазора, а слой W (буква l на рисунках 3 и 4) – снизу.
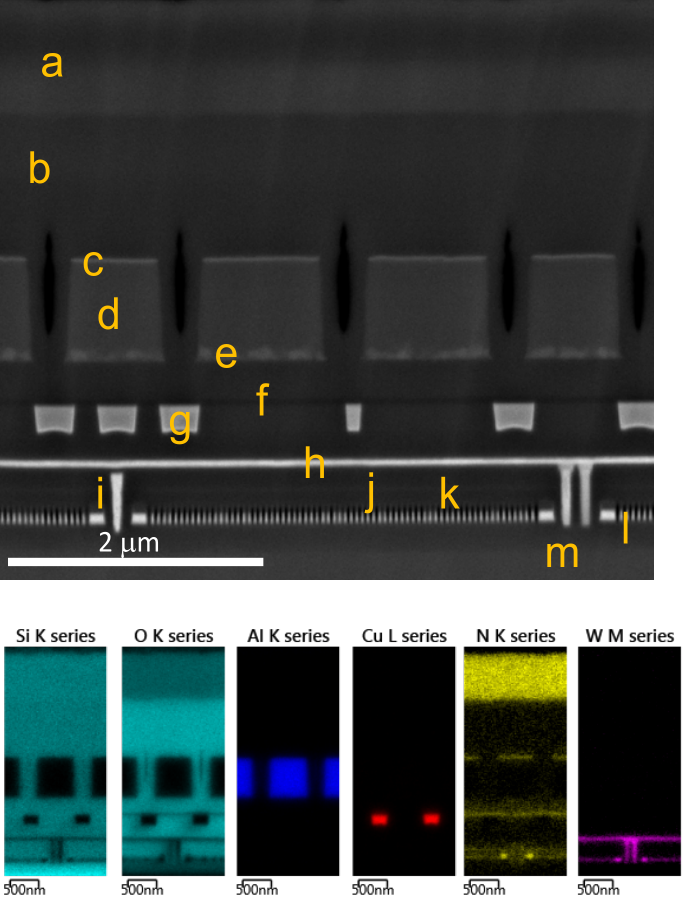
Рисунок 3 – Изображения поперечного сечения накопителя SSD с воздушными зазорами,
изготовленного методом ионно-лучевого травления при ускоряющем напряжении
ионов аргона 5 кэВ, и результаты картирования отдельных
химических элементов методом ЭДС при 5 кэВ. Буквенные обозначения слоев соответствуют
аналогичным обозначениям на рисунке 4.
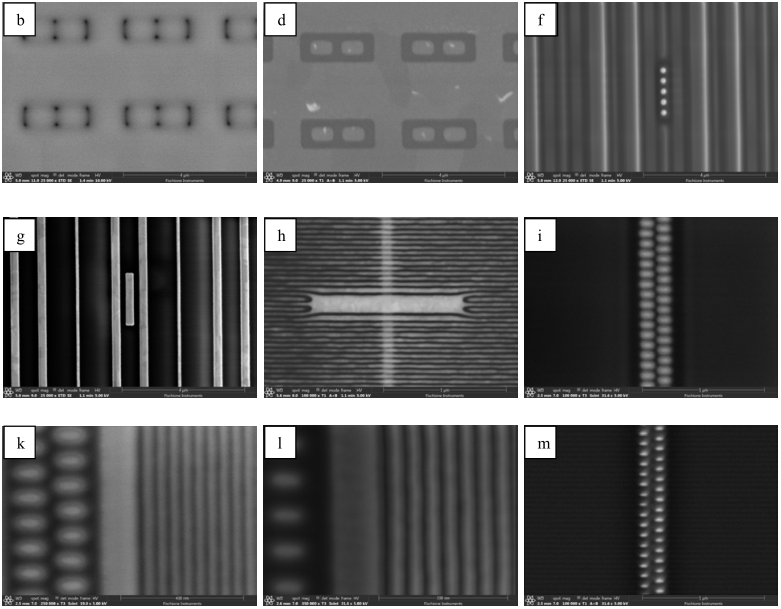
Рисунок 4 – Изображения топологических слоев, полученные с помощью СЭМ
с источником полевой эмиссии в ходе планарного препарирования
накопителя SSD с воздушными зазорами методом ионно-лучевого травления ионами аргона
Выводы
- Использование расфокусированного пучка ионов аргона обеспечивает хорошую точность изготовления поперечных сечений и полного послойного травления сложных микроэлектронных устройств.
- Полученная в результате поперечной и планарной обработки образца трехмерная информация позволяет безошибочно определить топологический слой, в котором возник дефект.
- Анализ данных проведенных экспериментов доказывает, что расфокусированный пучок ионов аргона удаляет материалы достаточно аккуратно, без появления нежелательных артефактов.
- Следовательно, не требуется дополнительная пробоподготовка для регистрации изображений поверхностей, обработанных расфокусированным ионным пучком, средствами СЭМ.
- ЭДС анализ элементного состава топологических объектов после их ионно-лучевой полировки возможен даже при низких энергиях электронного пучка по этой же причине.
Если Вас заинтересовало оборудование для пробоподготовки производителя Fischione, обращайтесь в нашу компанию. Наши специалисты подробно проконсультируют Вас и сориентируют по ценам на продукцию. Присылайте Ваши запросы на эл.почту info@sernia.ru или позвоните нам: +7 495 204 13
При подготовке статьи были использованы следующие материалы:
-
P. Nowakowski, M.L. Ray, P.E. Fischione, E.A. Fischione Instruments, Inc., Export, PA 15632 USA «Advanced tools and techniques for delayering and cross-sectioning semiconductor devices».
-
DD Wang et al., AIP Adv. 5 (2015), p. 127101-127019.
-
AC Bonora, Solid State Technol. 20 (1977), p. 55-62.
-
H Yap et al., Microelectron. Reliab. 55 (2015), p. 1611-1616.
-
JV Obona et al., Microsc. Microanal. 22 (2016), p. 56-57.
-
R Alvis et al., Conf. Proc. Int. Symp. Test. Failure Anal. (2015) p. 1-13.
-
P Nowakowski et al., Microsc. Microanal. 23 (Suppl 1) (2017), p. 12-13.
-
P Nowakowski et al., 28th Annual SEMI Advanced Semiconductor Manufacturing Conference (2017), p. 95-101.
-
P Nowakowski et al., Microsc. Microanal. 23 (Suppl 1) (2017), p. 1408-1409.
-
P Nowakowski et al., Microsc. Microanal. 22 (2016), p. 12–13.
-
P Nowakowski et al. European Microscopy Congress 2016: Proceedings (2016), p. 1082-1083.
-
P Nowakowski et al, European Microscopy Congress 2016: Proceedings (2016), p. 650-651.
- P Nowakowski et al., Microsc. Microanal. 23 (Suppl 1) (2017), p. 2224-2225.
Перейти в каталог оборудования для пробоподготовки Fischione Instruments >>>
Читать больше об оборудовании для пробоподготовки Fischione Instruments >>>