Введение
Для определения характеристик сложных наноструктур широко используются современные оже-нанозонды нового поколения [1]. С помощью этих систем можно выполнять высокоточный анализ, например анализ в точке, по линии, профилирование по глубине и оже-картирование. Кроме того, недавно разработанные специализированные зонды (например, JEOL JAMP-9500F и PHI-700 Xi) показывают поразительную возможность разрешения наноструктур и более высокий уровень чувствительности.
Таким образом, эти системы становятся все более и более интересными для большинства приложений, таких как фотоэлектрические (PV) солнечные элементы [2-3], кремниевые нанопроводники [4-5], переходные отверстия из углеродных нанотрубок (CNT) [6], BAM (Bundesanstalt für Materialforschung und prüfung - Федеральный институт исследований и испытаний материалов) эталонные образцы [7] и совместимые металоксидные полупроводниковые (КМОП) устройства [8-11]. Тем не менее, некоторые проблемы, такие как дрейф изображения и эффекты нагрева, по-прежнему остаются серьезным вызовом.
В системе оже-микрозонда с полевой эмиссией JEOL JAMP-9500F [1] используется электростатический полусферический анализатор (HSA) с многоканальными детекторами. Энергетическое разрешение (ΔE / E) может варьироваться от 0,05% до 0,6%, а максимальное латеральное разрешение составляет 8 нм (25 кВ, 1 нА) для оже-визуализации и 3 нм (25 кВ, 10 пА) для изображений во вторичных электронах. В системе PHI-700 Xi Nanoprobe [2] используется анализатор с цилиндрическим зеркалом (CMA) с коаксиальной электронной пушкой. Энергетическое разрешение может варьироваться от 0,1 до 0,5%, а латеральное разрешение составляет 8 нм (20 кВ, 1 нА) для оже-анализа и 6 нм (20 кВ, 1 нА) для SEM.
Эксперимент
Эксперимент проводился для сравнения двух оже-систем с разной геометрией сбора оже-электронов, как показано на рисунке 1. Обратите внимание, что более высокая чувствительность возможна только на участке образца, обращенном к анализатору. В зависимости от геометрии и положения анализатора на оже-изображении виден или не виден эффект затенения.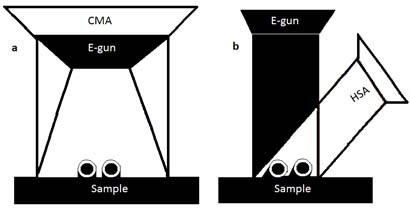
Рисунок 1 - Геометрия (а) коаксиального анализатора системы PHI-700 Xi и (б) некоаксиального анализатора системы JEOL JAMP-9500F
Анализ проводился при напряжении электронного пучка 20 кВ; ток 10 нА (размер пятна ~ 10 нм) на образце Al0.7Ga0.3As/GaAs и 5 кВ; ток 10 нА (размер пятна ~ 40 нм) для образца PV. Примечание: для анализа образцов BAM и PV использовали разрешение 0,5% для обоих инструментов. Перед оже-анализом было выполнено травление аргоном при 3 кэВ в течение 120 секунд с током ионов 3 мкА для удаления углеродного загрязнения с поверхности образца. Все образцы были проанализированы в условиях высокого вакуума (10-7 Па). Эталонный образец BАМ-L200 представляет собой поперечное сечение эпитаксиально выращенных слоев Al0.7Ga0.3As и GaAs на подложке GaAs [13].
РЕЗУЛЬТАТЫ
JEOL JAMP-9500F
На рис. 2 показаны SEM- изображение с высоким разрешением образца Al0.7Ga0.3As/GaAs и оже-спектры, полученные в результате точечного анализа, указанного на SEM-изображении. В точках 1 и 3 (темные контрастные области) оже-спектры показывают почти идентичные сигнатуры, состоящие из O, Ga, As и Al, тогда как в точке 2 (яркая контрастная область) видны только пики O, Ga и As. Присущее углеродное загрязнение было удалено перед анализом, поэтому идентификация O указывает на присутствие слоя естественного оксида.
Рисунок 2 - SEM-микрофотография с большим увеличением образца BAM Al0.7Ga0.3As/GaAs, полученная с помощью полевого оже-микрозонда JEOL JAMP-9500F (20 кВ, 10 нА, наклон 30 °): a) точечный анализ со вставкой, b) линейный анализ (относительная концентрация в зависимости от вытеснения) и в) соответствующие оже-спектры (а). Примечание в (b): i = 691 нм Al(0.70)Ga(0.30)As; ii = 293 нм; iii = 19.5 нм; iv = 195 нм; v = 136.5 нм; vi = 96.5 нм Al(0.70)Ga(0.30)As
Количественные результаты анализа оже-точки представлены на рис. 3. Как и ожидалось, содержание As довольно постоянное во всех трех областях. Обогащение Al, наблюдаемое для точек 1 и 3, позволяет отнести темную часть SEM-изображения к линиям Al0.7Ga0.3As.

Рисунок 3 - Относительные атомные концентрации (ат.%), Соответствующие точечному анализу на рисунке 2 (а)
PHI 700Xi
Другой оже-анализ был выполнен с помощью системы PHI 700Xi, сосредоточив внимание на самых тонких линиях Al0.7Ga0.3As (см. рис.4). Структура состоит из 6 прямоугольных решеток с периодами от 76,5 до 18 нм. В этом случае падающий электронный луч шаг за шагом проходит через одномерную область или линейное сканирование на поверхности образца. Интенсивность или относительная концентрация обнаруженных элементов (O, Al, Ga и As) измеряется попиксельно, обеспечивая одномерный профиль линии Оже.
Результаты показывают, что контраст Ga различим для каждого периода, даже если в самых тонких (<21 нм) три полосы каждой решетки смешаны. Контрасты O, As и Al, по-видимому, следуют за модуляцией сигнала Ga. Это не ожидаемая тенденция для As, для которой сигнал должен оставаться постоянным. Эти результаты подтверждают результаты, полученные с помощью микрозонда JEOL (рис. 2b). Предполагается эффект шероховатости поверхности, вызванный предпочтительным процессом распыления во время предварительной очистки поверхности. В дальнейшем необходимы исследования на AFM для подтверждения (или опровержения) этой гипотезы.
Согласно анализу линейного сканирования, для обеих систем очевидно (см. Рисунок 2 (b) для системы JEOL и рисунок 4 для системы PHI), что контраст изображения SEM соответствует не только реальному химическому контрасту, но и топографии поверхности. Примечательным моментом в системе JEOL является то, что линия Al - нечеткая из-за интенсивного сигнала линий Ga и As, но в системе PHI она видна визуально и следует за сигналом линии As.

Рисунок 4 - Нанозонд PHI-700 Xi, образец BАМ (Al / GaAs) (20 кВ, 10 нА, наклон 0 °); a) СЭМ-микрофотография с большим увеличением, b) Оже-анализ по линии (относительная концентрация в зависимости от вытеснения)
JEOL JAMP-9500F Оже-микрозонд с полевой эмиссией и PHI-700 Xi нанозонд
Фотоэлектрический образец (PV)
Вторым исследовали фотоэлектрический образец.На рисунке 5 показаны результаты точечного анализа обеих сторон PV-образца, то есть границы раздела a-Si: H (p)/ITO и интерфейса a-Si: H (n)/ZnO/Al, , выполненного с помощью Оже-системы JEOL JAMP-9500F. На рисунке 5 (а) показано SEM-изображение границы раздела с большим увеличением с четырьмя точками анализа, в разных частях образца. В каждой точке обнаружены следующие элементы: 1) C и Si; 2) In, Sn, O и Si; 3) C, O и Si; 4) In, Sn и O.Другое изображение границы раздела с большим увеличением a-Si: H (n)/ZnO/Al с тремя точками анализа показано на рисунке 5 (c). Как и ожидалось, Al, Zn и Si обнаружены в точках 1, 2 и 3 соответственно. Производные спектры, полученные в различных областях обоих интерфейсов, показаны на рисунках 5 (b) и 5 (d). Идентификация каждого уровня удовлетворительно выполняется на обоих интерфейсах.

Рисунок 5 - SEM-микрофотография поперечного сечения фотоэлектрического образца с большим увеличением. Оже-микрозонд JEOL JAMP-9500F (5 кВ, 10 нА, наклон 0 °): а) точечный анализ (интерфейс a-Si: H (p)/ITO), b) соответствующие оже-спектры (а), c) точки анализа ( a-Si: H (n)/ZnO/Al) и d) соответствующие оже-спектры (c).
На рисунке 6 показаны развертки линии Оже, измеренные с помощью системы PHI 700Xi на границе a-Si: H (n)/ZnO/Al. Профиль концентрации ясно показывает последовательные слои, наблюдаемые на SEM-микрофотографии поперечного сечения.
Все эти результаты демонстрируют интерес Оже-электронной спектроскопии (AES) для описания детального химического состава тонких многослойных образцов по их поперечному срезу. Ограничения, связанные с шероховатостью поверхности, еще предстоит выяснить.

Рисунок 6 - SEM-микрофотография поперечного сечения фотоэлектрического образца с большим увеличением. Нанозонд PHI 700Xi (5 кВ, 10 нА, наклон 0 °): а) SEM-изображение и b) соответствующие спектры Оже-линий (относительная концентрация в зависимости от смещения).
ВЫВОД
Чувствительность / энергетическое разрешение двух систем
Поверхностная чувствительность систем AES, разработанных как JEOL, так и PHI, начинается с достаточно короткой неупругой длины свободного пробега оже-электронов, обычно 5 нм или меньше [14]. Лишь оже-электроны, которые возникают в пределах нескольких монослоев поверхности с незначительными потерями энергии, вносят вклад в сигнал оже-пиков. Электроны, которые испытывают разнообразные процессы потери, вносят свой вклад в непрерывный фон. Оже-нанозонды обеспечивают очень высокий уровень чувствительности к поверхности по сравнению с другими аналитическими методами, такими как EELS, EDX и т. д.Возможности систем JEOL и PHI с точки зрения чувствительности в основном связаны со спецификой анализатора. Система JEOL JAMP-9500F Auger оснащена анализатором типа HSA, тогда как система PHI использует анализатор CMA. CMA обеспечивает лучшую чувствительность (от 0,1 до 1 ат.% В зависимости от анализируемого элемента), о чем свидетельствует сигнал Al, обнаруживаемый только системой PHI для образца BAM. Преимущество HSA - лучшее энергетическое разрешение (до 0,05%) для детального анализа оже-линий с точки зрения состояний химической связи.
Артефакты
Хотя существуют различные возможные артефакты и ограничения, связанные с образцом, которые могут ограничивать применимость AES: a) эффекты нагрева [15], а также химические изменения [16] могут быть вызваны бомбардировкой энергичными электронами, b) непроводящий образец может заряжаться под пучком энергичных электронов, вызывая энергетический сдвиг в спектре и дрейф изображения на в SEM; c) для определенного типа аналитической геометрии рельеф поверхности или шероховатость могут привести к затенению части поверхности от пучка электронов, ионный пучок или препятствует обнаружению Оже-электронов, d) вибрации и акустический шум, вызывающие дрейф электронов, являются ключевыми моментами, которые необходимо контролировать должным образом в долгосрочных измерениях, необходимых для Оже-микроскопии.Геометрия анализатора-цилиндрическое зеркало (CMA) и полусферического анализатора (HSA)
CMA имеет солидное геометрическое преимущество постоянного сбора электронов вокруг азимута 360°. В системе PHI коаксиальная электронная пушка и геометрия анализатора обеспечивают лучшую чувствительность и беспрепятственный обзор наноструктур, чем разработанная Jeol оже-система с несоаксиальной геометрией (рис. 1). Расположение CMA упрощает положение точки анализа и может уменьшить эффекты топографического затенения для любого наноструктурированного образца.Гибкость входной оптики - главная сила HSA. Повышенное энергетическое разрешение может способствовать разделению перекрывающихся Оже-пиков или сдвигу пиков или вариациям формы как следствие химической связи. Строго определенный телесный угол приема сигнала, определяемый входной оптикой, тем не менее, делает HSA значительно более подверженным сбоям, связанным с топографией образца.
Влияние топографии поверхности
На рисунке 2 показан очень хороший пример оже-анализа в точке на двух разных участках слоев Al0.7Ga0.3As и GaAs на образце BAM. Для этого использовалось энергетическое разрешение (ΔE / E) 0,5% при размере пятна 10 нм. Для первого анализа, выполненного на более толстых линиях, как оже-спектры, так и количественные результаты выделяют сигнатуру Al в темных областях, соответствующих линиям Al0.7Ga0.3As. Коррелированная модуляция количества As и Ga на профилях концентрации линий указывает на топографический артефакт, вызванный неоднородным распылением.Эта гипотеза также подтверждается постоянством количества As, определенного точечным анализом. Поэтому для таких структурированных поверхностей локальный точечный анализ более уместен, чем анализ по линии, который учитывает точечное изменение глубины выхода и дисперсии собираемых оже-электронов. Несмотря на этот эффект, анализ более тонких слоев показывает, что можно обнаружить слои толщиной около 21 нм.
*При подготовке статьи были использованы следующие материалы:
- D. Karpuzov, A. He and S. Xu, Surf. Interface Anal. 38, 287-291 (2006).
- J. De La Torre, G. Bremond, M. Lemiti, G. Gouillot, P. Mur, N. Buffet, Thin Solid Films, 163, 511 (2006).
- J. D. L. Torre, G. Bremond, M. Lemiti, G. Guillot, P. Mur and N. Buffet, Mater. Sci. Engg. C, 26, 427- 430 (2006).
- V. T. Renard, M. Jublot, P. Gergaud, P. Cherns, D. Rouchon, A. Chabli and V. Jousseaume, Nat. Nanotech., 4, 654 (2009).
- N. Geyer, Z. Huang, B. Fuhrmann, S. Grimm, M. Reiche, T. K. N. Duc, J. D. Boor, H S. Leipner, P. Werner and U Gosele, Nano Lett., 9, 3106-3110 (2009).
- J. C. Coiffic, M. Fayolle, P. Faucherand, M. Levis, H. L. Poche, J. Dijon and S. Maitrejean, phys. Stat. Sol. (a), 205, 1399-1401 (2008).
- G. Bernatz, S. Nau, R. Rettig, H. Jansch, W. Stolz, J. Appl. Phys., 86, 6752-6757 (1999).
- M. Wong and K. C. Saraswat, IEEE Trans. Electron Devices, 36, 1355-1361 (1989).
- Y. Choi, N. Lindert, P. Xuan, S. Tang, D. Ha, E. Anderson, T. J. King, J. Bokor and C. Hu, IEDM Tech. Dig., 421-424 (2001).
- T. Tezuka, N. Sugiyama, T. Mizuno and S. Takagi, VLSI Tech. Dig., 96-97 (2002).
- R. Chau, J. Kvalieros, B. Doyle, A. Murthy, N. Paulsen, D. Lionberger, D. Barlage, R. Arghavani, B. Roberds and M. Doczy, IEDM Tech. Dig., 621-624 (2001).
- M. Senoner, T. Wirth, W. Unger, W. Osterle, I. Kaiander, R. L. Sellin, and D. Bimberg, Nanoscale Calibration Standards and Methods, Chapter 21, Wiley-VCH Verlag GmbH, 2006.
- 12. M. Senoner, T. Wirth and W. Unger, Surf. And Int. Anal. 36, 1423 (2004).
- K. D. Childs, B. A. Carlson, L. A. LaVanier, J. F. Moulder, D. F. Paul, W. F. Stickle, D. G. Watson, Handbook of Auger electron spectroscopy, Physical Electronics Inc. (1995).
- D. Sakai, N. Sanada, J. S. Hammond and H. Iwai, J. Surf. Anal., 12 (2) (2005).
- E. Martinez, N. Rochat, C. Guedj, C. Licitra, G. Imbert, Y. Le Friec, J. of Appl. Phys. 100, 124106 (2006).
- P. Yadav, M. Bouttemy, E. Martinez, J. Vigneron, O.Renault, P. Mur, D. Munoz, A. Etcheberry, A. Chabli - «Analytical Study of BAM (Al/GaAs) and Photovoltaic Samples Using State-of-The-Art Auger Nanoprobes».


