Методики для анализа отказов
В помощь технологуВ предыдущем выпуске новостной рассылки мы рассказали об электронно-ионных методах для локализации отказа.
В сегодняшней статье речь пойдет о атомно-силовых методах и методике нанозондирования, используемых для анализа отказов в микроэлектронике.
Анализ отказов – это исследование характера и механизма отказа с использованием оптических, электрических, физических и химических методик анализа. В зависимости от типа дефекта применяются различные методы локализации отказа: электронно- и ионно-лучевые; зондовые и атомно-силовые; оптические.
В данной статье разговор пойдет об атомно-силовой микроскопии и нанозондовом тестировании, применяемых для проведения анализа отказов.
Методики атомно-силовой микроскопии, применяемые в анализе отказов
 Атомно-силовая микроскопия, АСМ (AFM) – это метод, используемый для наблюдения шероховатости поверхности образца путем обнаружения вертикальных перемещений зонда, вызванных атомной силой между кончиком зонда, помещенного близко к поверхности образца, и самим образцом.
Атомно-силовая микроскопия, АСМ (AFM) – это метод, используемый для наблюдения шероховатости поверхности образца путем обнаружения вертикальных перемещений зонда, вызванных атомной силой между кончиком зонда, помещенного близко к поверхности образца, и самим образцом.
Как правило, атомно-силовой микроскоп имеет дополнительные модули, которые значительно расширяют возможности АСМ. Для реализации процедуры анализа отказов будут полезны следующие методики ACM:
- Сканирующая микроскопия растекания - Scanning Spreading Resistance Microscopy (SSRM) - данная методика использует проводящий зонд и является контактной. Между образцом и зондом создается разность потенциалов и по изменению протекающего тока оценивается сопротивление поверхности.
- Сканирующая емкостная микроскопия - Scanning Capacitance Microscopy (SCM) - методика является полу-контактной, при первом проходе оценивается рельеф поверхности. Второй проход проводится на некотором расстоянии от образца и в соответствии с первым проходом, к зонду и образцу прикладывается смещение. При втором проходе оценивается поверхностная емкость образца.
- Сканирующая микроскопия зонда Кельвина - Kelvin probe force microscope (KPFM) - как и в методике SCM, выполняется два прохода, первый – для определения рельефа поверхности, второй – для оценки распределения поверхностного потенциала.
Методики SSRM и SCM могут использоваться не только для получения информации о геометрии поверхности, но и для определения поверхностного заряда, областей диффузии и локализации дефектов в диэлектриках и областях с высоким сопротивлением.
Нанозондовое тестирование
 Зондовое тестирование используется для оценки электрических характеристик исследуемого образца. В зависимости от визуализации и размера зондов выделяют метод нанозондового анализа.
Зондовое тестирование используется для оценки электрических характеристик исследуемого образца. В зависимости от визуализации и размера зондов выделяют метод нанозондового анализа.
Устройство нанозондирования использует субмикронную зондирующую иглу, чтобы соединиться с проводником или контактом, с которого была удалена защитная пленка, и таким образом обеспечивает оценку электрических характеристик устройства. Эта технология помогает локализовать место отказа до уровня наблюдения TEM и облегчает физический поиск причины отказа.
Более того, поскольку этот метод позволяет непосредственно оценивать электрические характеристики в месте отказа, он определяет основное направление для анализа механизма отказа от физической причины отказа до выяснения симптомов отказа. Устройство нанозондировния позволяет обнаружить отказы на этапах разработки и массового производства.
Система нанозондового анализа как правило интегрируется в сканирующий электронный микроскоп, так как оптические методы не способны визуализировать объекты с достаточным разрешением. Для более быстрой навигации, как правило, используется система CAD-навигации для более быстрого нахождения интересующего объекта.
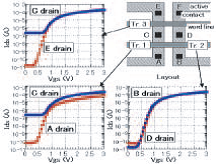 На рисунке слева показан пример анализа. Приведен пример памяти SRAM, в которой один бит состоит из шести МОП-транзисторов. Даже, если локализован дефектный бит, анализ в TEM не применим, так как область слишком обширна. В приведенном примере в дефектном бите был идентифицирован отказ в контакте (C) и измерены характеристики МОП-транзисторов вокруг этого контакта. После идентификации отказа может использоваться анализ в TEM дефектного контакта и быть приняты соответствующие меры для процесса изготовления.
На рисунке слева показан пример анализа. Приведен пример памяти SRAM, в которой один бит состоит из шести МОП-транзисторов. Даже, если локализован дефектный бит, анализ в TEM не применим, так как область слишком обширна. В приведенном примере в дефектном бите был идентифицирован отказ в контакте (C) и измерены характеристики МОП-транзисторов вокруг этого контакта. После идентификации отказа может использоваться анализ в TEM дефектного контакта и быть приняты соответствующие меры для процесса изготовления.
EBIC
При синхронизации сканирования электронного луча и предусилителя тока с помощью системы нанозондового тестирования реализуется методика EBIC – electron beam induced current (ток, индуцированный электронным лучем). При сканировании поверхности электронным пучком в полупроводниковом образце возникают электронно-дырочные пары и начинает течь ток.
Если синхронизировать измерение тока со сканированием, то можно визуализировать этот ток. Данный метод используется для идентификации скрытых проводников, дефектов в полупроводниках или для изучения неосновных носителей.
Ниже на рисунках 1 и 2 – примеры использования методики EBIC.
Рис.1 Изображение EBIC в синем и SEM-изображение в сером цвете, показывающее локальные места сбоя на D44 и D15. Усилитель EBIC подключен между зондами P1 и P2
Рис.2 В результате дополнительных исследований EBIC и других методов физического анализа установлена причина утечки в п-н переходах – нарост силицида (STEM изображение кросс секции).