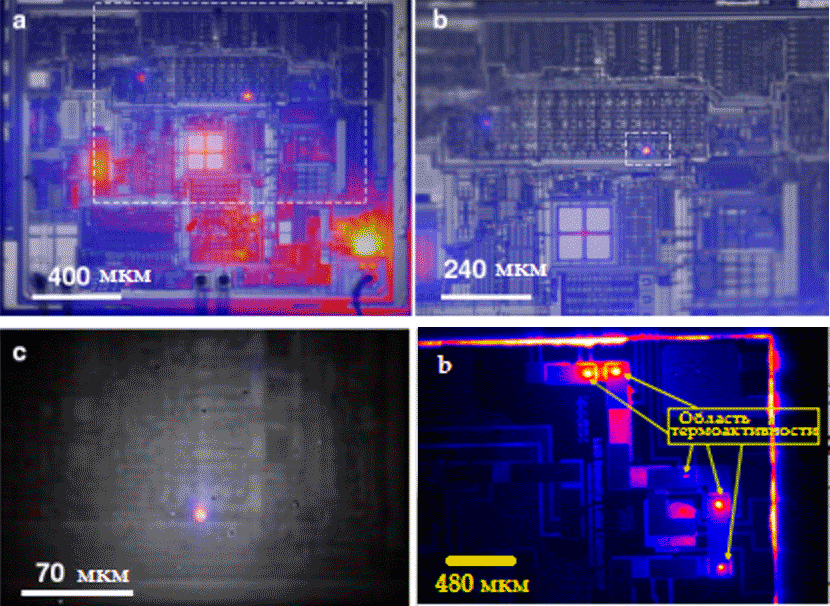
Эффективное пространственное разрешение
Теоретические основы теплового распространения в ИМС
Если для анализа неисправностей интегральных микросхем применяется СТГ (технология синхронной термографии), критическим ограничением его является предел пространственного разрешения. Для точечного источника тепла, расположенного на поверхности устройства, поле модуляции температуры поверхности при небольшом боковом смещении r от источника, уменьшается на 1/r, независимо от расстояния тепловой диффузии.
Даже для низких частот синхронизации точечные источники тепла на поверхности могут быть четко локализованы.
От частоты синхронизации зависит только степень расширения ореола вокруг них. Боковое распространение тепла является более критичным для источников тепла большого размера. Такое распределение тепла можно рассматривать даже как преимущество, поскольку оно гарантирует, что на обзорном изображении, с небольшим увеличением, невозможно пропустить источники тепла малого размера.
Следует обратить внимание, что для синхронизированных изображений, которые в любом случае могут казаться более или менее расплывчатыми из-за бокового распространения тепла, или в связи с тем, что фактический источник тепла может лежать на некоторой глубине ниже поверхности, разрешение не является критическим параметром.
Даже в том случае, если источник тепла является точечным, положение его центра обычно можно оценить с точностью до 1 пикселя путем нахождения центра насыщенности размытого пятна. Основная проблема с пространственным разрешением заключается в том, что оператору по-прежнему необходимо иметь возможность навигации по поверхности ИС.
“Проблемное место” в локализации дефекта
Основная проблема с пространственным разрешением заключается в том, что оператору по-прежнему необходимо иметь возможность навигации по поверхности ИС. Сегодня шаблоны топологии могут быть настолько малы, что распознавание деталей с помощью обычного объектива микроскопа в среднем ИК-диапазоне могут быть недоступны. Поэтому задача улучшения пространственного разрешения состоит в том, чтобы получить содержательное изображение топографии, которое позволит ориентироваться на поверхности. Только тогда локальные пики в синхронизированных изображениях могут быть привязаны к топологии ИС, с наибольшей достоверностью.К сожалению, для образцов, находящихся при комнатной температуре, в среднем диапазоне, световая интенсивность экспоненциально увеличивается с длиной волны. Таким образом, подавляющая часть света концентрируется вблизи 5 мкм и только незначительная часть появляется при 3 мкм. Следовательно, для хорошего объектива микроскопа с NA = 0,7 (при угле поглощения света θ равном +/-45°) предел пространственного разрешения, ограниченный дифракцией, для l = 5 мкм составляет ∆x = 3,6 мкм. Этот предел может быть улучшен до 1 мкм, применением твердотельной иммерсионной линзы (SIL) (рис. 1). В простейшем случае это полусфера, выполненная из кремния или германия, которая помещается своей плоской нижней поверхностью на плоскую поверхность устройства.
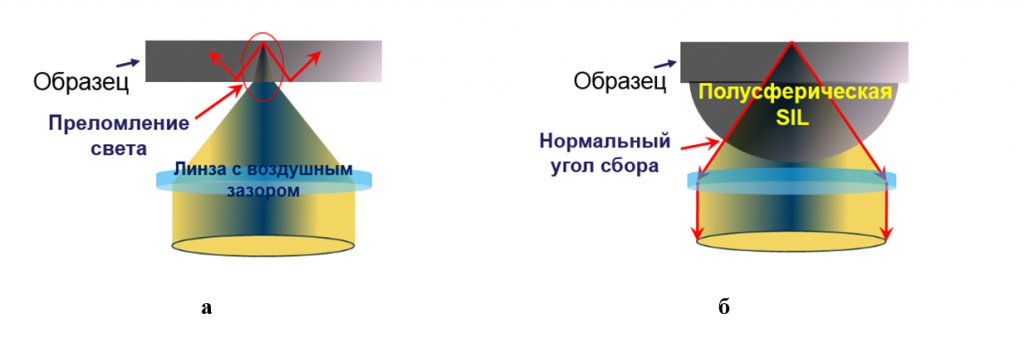
Рисунок 1 – Сравнение объективов с воздушным зазором (а); с иммерсионной линзой (б)
Способ повышения разрешения для визуализации топологии ИМС
Эта линза обеспечивает дополнительное оптическое увеличение, по меньшей мере, равное коэффициенту дифракции n материала, который составляет около 3,5 для Si и 4 для Ge. Так как при этом объект «подведен» к материалу линзы SIL, длина волны света, падающего на него, меньше на величину n, а апертура NA больше на этот коэффициент.
Таким образом, если щель между поверхностью образца и линзой SIL значительно меньше 1 мкм, можно увидеть поверхностные структуры с размерами до 1 мкм. Таким же образом для точечных источников тепла поверхность пятен на изображении СТГ уменьшается. SIL могут применяться как с лицевой, так и обратной стороны образцов, при условии, что поверхности образцов тщательно отполированы.
*При подготовке статьи были использованы следующие материалы:
- J. Ross “Microelectronics Failure Analysis Desc Reference. Sixth Edition” USA: «ASM International», 2011. – 660 стр.
Читайте по теме:
- Цикл статей о тепловом анализе отказов с помощью ИК-термографии. Часть 1 – «Технология синхронной термографии (СТГ/Lock-In Thermography)» >>>
- Цикл статей о тепловом анализе отказов с помощью ИК-термографии. Часть 3 – «Примеры применения» >>>
Планируется к выпуску продолжение – следите за анонсами на сайте:
-
Цикл статей о тепловом анализе отказов с помощью ИК-термографии. Часть 4 – «Выводы».
