Применение АСМ в анализе отказов
Анализ отказов - это ряд действий для определения местонахождения дефекта микросхемы и установления причины его возникновения. Применение АСМ позволяет значительно улучшить качество локализации отказов.
Анализ отказов - один из важнейших этапов производства полупроводниковых приборов. Благодаря анализу отказов производители могут изменить технологический процесс, и тем самым избежать причины появления отказа. Своевременное выявление отказов позволяет значительно сократить количество микросхем, вышедших из строя в процессе эксплуатации, и, соответственно, повысить выход годных микросхем.
Атомно-силовой микроскоп - один из важнейших инструментов в поиске неисправностей. Развитие АСМ не остановилось на уровне своего создания, установки постоянно модифицируются, специализируясь для решения более узких и профильных задач. В данной статье представлено два примера применения АСМ для улучшения качества анализа отказов.
C-AFM - потоковый анализ в наноразмерных полупроводниковых приборах
В 2013 году была опубликована статья [1], которая представляла результаты исследований методом потокового анализа на основе проводящей атомно-силовой микроскопии (англ. C-AFM - Conductive Atomic Force Microscopy). Она позволила проводить анализ отказов и исследовать отклонения в технологическом процессе с возможностью точного позиционирования по всей области пластины в технологическом процессе изготовления динамической памяти с произвольным доступом (англ. DRAM Dynamic Random Access Memory).
C-AFM сканирование поверхности полупроводникового устройства осуществляется проводящим зондом (кантилевером) в контактном режиме. Как правило, верхние слои микросхемы предварительно удаляются вплоть до вольфрамовых контактов, подключенных к транзисторам. На подложку микросхемы подается напряжение смещения постоянного тока относительно кантилевера. Протекающий через острие кантилевера электрический ток измеряется и представляется в виде изображения.
Таким образом, на карте распространения токов можно идентифицировать контакты, подключенные к областям транзисторов с аномальной электропроводностью (рис.1).
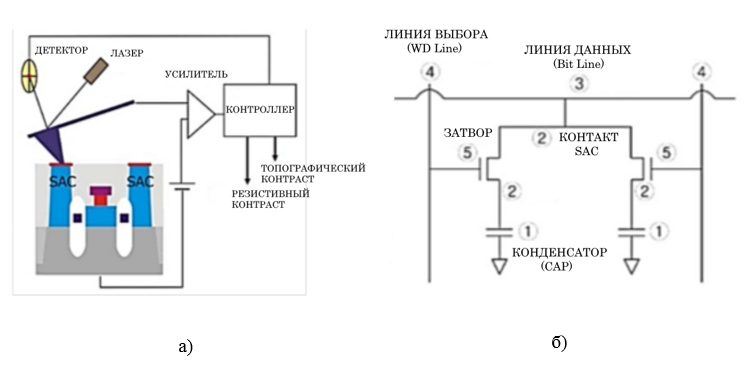
Рисунок 1 - C-AFM анализ структуры ячейки DRAM: (а) эквивалентная схема структуры ячейки DRAM; (б) структура образца и схема анализа C-AFM структуры DRAM.
Диагностика отказов в мобильных структурах DRAM
Благодаря C-AFM удалось выделить новый способ неразрушающей диагностики резистивных отказов в мобильных структурах DRAM. В частности, исследователи сосредоточились на процессе самонастраивающегося контакта (англ. SAC - Self-Aligned Contact), поскольку отказ, возникающий в процессе SAC является одним из доминирующих факторов, вызывающих ухудшение выхода годных изделий DRAM, при этом являясь физически невидимым дефектом.
Благодаря установлению точных значений параметров SAC-процесса с помощью встроенного анализа C-AFM, был предложен метод контроля и снижения доли бракованных изделий при изготовлении DRAM.
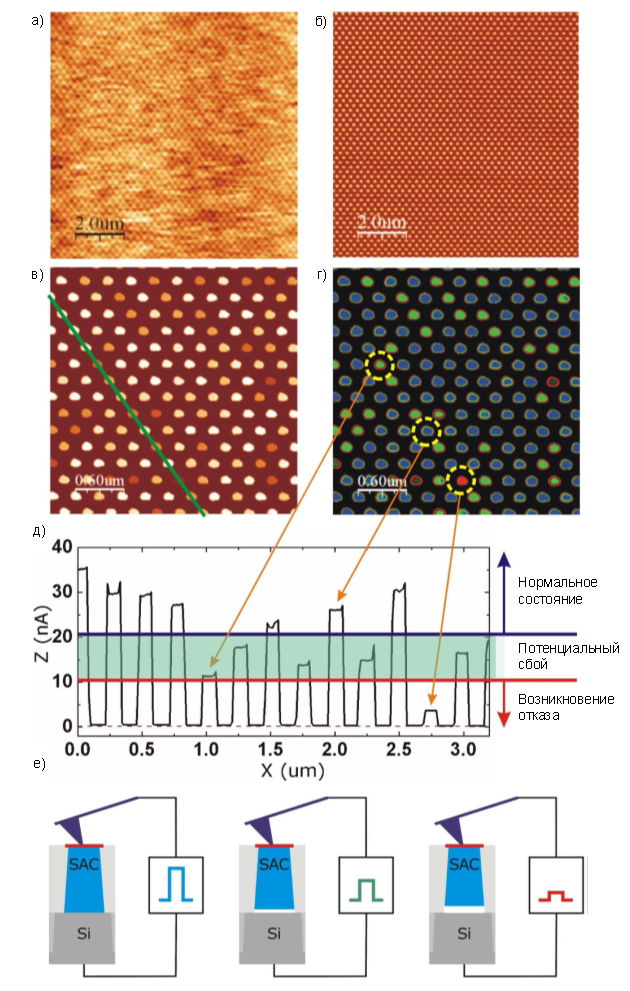
Рисунок 2 - Анализ отказов структур SAC с использованием C-AFM: (a) топография C-AFM-изображения нормального SAC; (б) соответствующее текущее изображение C-AFM при смещении 4,0 В для нормального SAC; (в) текущее изображение C-AFM при смещении 4,0 В для SAC без процесса PNC; (г) соответствующее цветовое отображение текущего изображения C-AFM для определения критериев отказа (синий цвет: нормальное состояние, зеленый цвет: условие потенциального отказа, красный цвет: условие отказа); (д) соответствующий профиль линии поперечного сечения текущего уровня с критериями отказа; (е) схемы анализа C-AFM для определения случаев нормальных, предельных и отказавших структур SAC.
В результате проделанной работы были предложены точные значения параметров для отображения резистивных отказов при изготовлении SAC-структур и установлено, что причиной отказов SAC является нижний слой оксида кремния. Кроме того, было обнаружено, что процесс PNC (англ. Plasma Native Oxide Cleaning), проводимый на установках плазмохимического травления, имеет решающее значение для определения электрического качества SAC-структур. PNC используют для удаления нижнего оксидного слоя, приводящего к дефектам в SAC-структурах.
Предложенные параметры измерений и граничные значения характеристик SAC-структур с помощью встроенного анализа C-AFM, позволили получить метод увеличения выхода годных структур с пластины, предотвращая возникновение tRDL (tRDL – англ. Trench ReDistrbution Layers) отказов (вызывает нарушения допустимого интервала времени между вводом данных и отправкой на шину данных).
Дифференциальная C-AFM для анализа отказов полупроводниковых схем
В статье 2016 года были описаны эксперименты по усовершенствованию традиционного метода C-AFM для тестирования устройств типа «кремний на изоляторе» (КНИ) [2]. Они имеют скрытый оксидный слой (buried oxide layer, BOX), изолирующий активные области транзисторов от кремниевой подложки.
Такие устройства невозможно тестировать традиционным методом C-AFM в режиме постоянного тока, так как оксидный слой будет препятствовать протеканию электрического тока между зондом и образцом. Данное ограничение обходят путем специальной пробоподготовки с помощью систем со сфокусированным ионным пучком (FIB).
Разработанная авторами система позволяет сократить время локализации отказов интегральных схем, а также обеспечивает успешное тестирование устройств с КНИ, из-за того, что вместо напряжения смещения постоянного тока прикладывается напряжение смещения переменного тока.
Напряжение смещения подается в виде меандра, у которого верхняя часть имеет положительное значение напряжения, а нижняя – отрицательное. Сканирование осуществляется с той же скоростью, как и в случае C-AFM постоянного тока. Частота сигнала переменного тока зависит от скорости сканирования и количества пикселей сканируемого изображения.
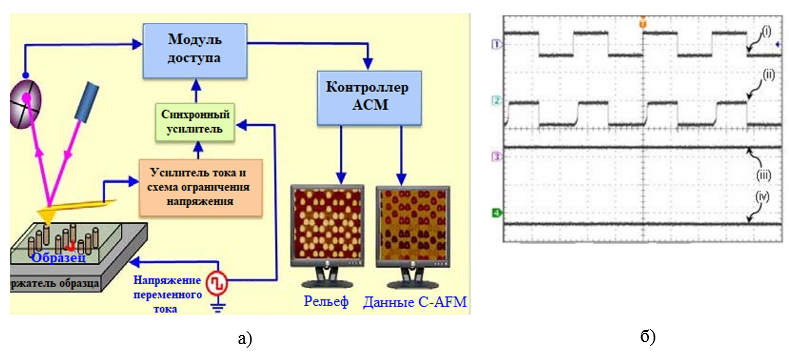
Рисунок 3 – а) Упрощенная структурная схема дифференциальной системы C-AFM, б) Примеры временных диаграмм сигналов, считанных с контактов (a) исправного p-n-перехода. Здесь: (i) напряжение переменного тока, (ii) входной сигнал синхронного усилителя, (iii) выход X синхронного усилителя, (iv) выход Y синхронного усилителя
Из-за периодической смены полярности подаваемого на образец переменного напряжения, применяемые для формирования изображений сигналы синхронного усилителя дают возможность получить информацию о поведении образца как при положительном, так и отрицательном напряжении смещения, за один проход сканирования.
Дифференциальная система имеет преимущество перед традиционным методом C-AFM постоянного тока, в котором тестирование выполняется в два этапа сканирования – один этап для подачи положительного напряжения смещения, второй – отрицательного.
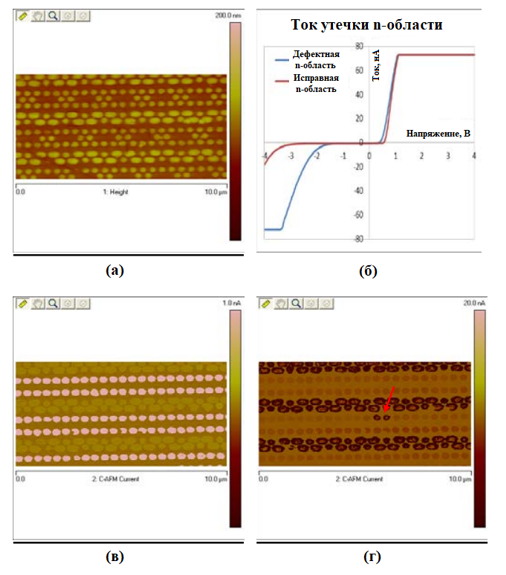
Рисунок 4 – Изображения устройства, имеющего дефект утечки n-области транзистора, полученные с помощью традиционной C-AFM постоянного тока: (a) изображение рельефа, (б) вольтамперная характеристика исправной и дефектной n-областей, (в) результат подачи положительного напряжения – дефект не обнаружен, (г) результат подачи отрицательного напряжения – дефект обнаружен
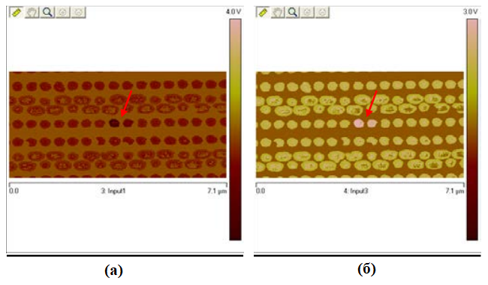
Рисунок 5 – Изображения устройства, имеющего дефект утечки n-области транзистора, полученные с помощью дифференциальной системы C-AFM: (a) изображение с выхода Y синхронного усилителя – дефект обнаружен, (б) изображение с выхода X синхронного усилителя – дефект обнаружен

Рисунок 6 – Изображения устройства, имеющего дефект утечки p-области транзистора, полученные с помощью традиционной C-AFM постоянного тока: (a) изображение рельефа, (б) вольтамперная характеристика исправной и дефектной p-областей, (в) результат подачи положительного напряжения – дефект обнаружен, (г) результат подачи отрицательного напряжения – дефект не обнаружен
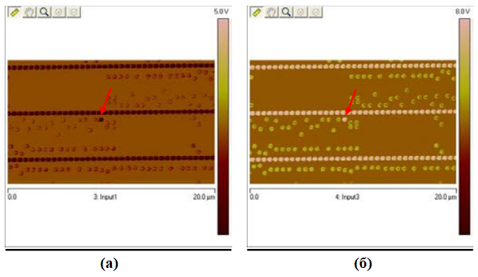
Рисунок 7 – Изображения устройства, имеющего дефект утечки p-области транзистора, полученные с помощью дифференциальной системы C-AFM: (a) изображение с выхода Y синхронного усилителя – дефект обнаружен, (б) изображение с выхода X синхронного усилителя – дефект обнаружен
ВЫВОДЫ
-
Использование дифференциальной C-AFM позволяет сократить время локализации дефектов интегральных схем и позволяет проводить тестирование образцов, выполненных по технологии КНИ, без дополнительной пробоподготовки с помощью FIB.
-
Постоянное сокращение геометрических размеров топологических элементов, увеличение функциональных возможностей и поиск новых материалов провоцируют развитие распространенных методов анализа отказов. Атомно-силовая микроскопия также не останавливается в развитии и является одним из важнейших инструментов анализа отказов.
*При подготовке статьи были использованы следующие материалы:
-
«Fast, exact, and non-destructive diagnoses of contact failures in nano-scale semiconductor device using conductive AFM» ChaeHo Shin, Kyongjun Kim, Jeonghoi Kim, Wooseok Ko, Yusin Yang, Sangkil Lee, Chung Sam Jun, Youn Sang Kim, Published 2013, Computer Science, Medicine, Scientific Reports;
-
«Differential C-AFM system for semiconductor failure analysis», Xinhua Zheng, Yu Thi Han, Pei Hong Seah, Guan Siong Lee, Kheaw Chung Chng, Published 2016, Materials Science, 2016 IEEE 23rd International Symposium on the Physical and Failure Analysis of Integrated Circuits (IPFA)
Если Вам необходима консультация специалиста по атомно-силовой микроскопии или оборудованию для проведения анализа отказов - обращайтесь в ООО "Серния Инжиниринг": +7 (495) 204 13 17, info@sernia.ru.ЧИТАЙТЕ ПО ТЕМЕ:
- Цикл статей об атомно-силовой микроскопии и микроскопах (АСМ). Часть 1 – «Принципы работы АСМ» >>>


