Анализ отказов позволяет выявить причины неисправности микросхемы
Надежность любых полупроводниковых устройств закладывается на этапе конструирования, а обеспечивается технологическим процессом изготовления. В связи с рыночными требованиями повышенной надежности при разработке устройств необходимо использовать анализ отказов, в результате которого выявляются причины неисправностей. Это особенно актуально для производства новых изделий или при переходе на новую партию, так как не всегда соответствие техническим условиям гарантирует исправную работу готовой микросхемы.
Существует множество параметров, которые влияют на характеристики и надежность устройства и не все из них можно учесть на начальных этапах разработки. Анализ отказов позволяет выявить и локализовать области неисправностей и, как следствие, выяснить их причину.
Редактирование цепей - важный этап анализа отказов
Одним из этапов после анализа отказов является редактирование с целью создания эталонного образца, который будет соответствовать всем техническим условиям. В настоящее время корректирование микросхем может осуществляться с помощью множества операций и существует большой выбор оборудования, которое позволят быстро и качественно произвести эту работу с прецизионной точностью. Основным инструментом для редактирования цепей на микро- и нано-уровнях является с ионно-лучевой микроскоп.
Ионно-лучевая микроскопия – основной инструмент редактирования
Ионно-лучевая микроскопия – это универсальный инструмент для редактирования цепей. Хотя почти все FIB могут «вырезать и вставлять», очевидно, что для комплексных изменений требуется оптимизация данных процессов и, следовательно, необходимость правильного набора опций инструмента.
Рис.1. Процедуры редактирования
Декапсуляция - удаление полимерного покрытия
Прежде чем приступить к редактированию цепей, необходимо произвести определенную работу по подготовке образца (см.рис.1). В случае, когда уже известно, что устройство не выполняет предписанные ему технические функции и произведен анализ отказов с локализацией неисправности, запускается процесс подготовки. Микросхему необходимо декапсулировать, удалив полимерное покрытие. Данные операции могли быть выполнены ранее для выявления причины отказа.
CAD навигация и корреляция с FIB
CAD навигация предоставляет возможность быстро ориентироваться относительно топологии образца и производить редактирование с высокой точностью, существенно снижая время работы оператора. Для этого необходимо произвести корреляцию CAD и FIB. Привязка образца к схеме топологии происходит в несколько этапов. В начале делается грубая привязка по краям образца, после этого необходимо увеличивается область интереса и происходит более точная привязка уже по меньшим элементам схемы.
Точное позиционирование FIB
Чтобы привязать схему топологии к образцу используется ИК камера. Она позволяет просматривать реальную топологию образца сквозь слои кремния с обратной стороны или пассивации с лицевой стороны. После привязки образца в ИК режиме, топология накладывается на ионное изображение, что позволяет производить операции с высокой точностью.
Материалы и химическое ассистирование
Как уже говорилось, ионно-лучевой микроскоп – это универсальный инструмент для редактирования цепей. Редактирование цепей предъявляет высокие требования к оператору FIB. Помимо технических знаний зачастую требуется творческий подход и креативность. Качество результата так же зависит от выбора химических газов и электрических параметров. Для выбора верного рецепта необходимо знать материалы микросхемы, где непосредственно будет осуществляться редактирование.
Для процесса редактирования цепей материалы разделяют на 4 группы: оксид кремния, алюминий, медь, диэлектрики с пониженной диэлектрической проницаемостью.
Травление оксида кремния: Травление оксида кремния с использованием XeF2
позволяет увеличить скорость травления более чем в 5 раз, кроме того при использовании XeF2 для данного процесса требуется меньший ток.
Травление меди: Медь чувствительна к воздействию галогенов. XeF2 не влияет на скорость ее травления, так же для меди характерно появление осаждений, поэтому необходимо дополнительно напылять изолятор.
Травление диэлектриков: Скорость травления диэлектриков с пониженной диэлектрической проницаемостью с использованием XeF2 выше. В зависимости от диэлектрической проницаемости материала возможно подобрать химические газы, которые повысят скорость больше чем XeF2.
Напыление: В зависимости от необходимости создания контакта, напыление производится либо проводником, либо диэлектриком. Диэлектрик TMCTS напыляется для создания непроводящего слоя или для защиты участка вокруг области травления. В качестве проводящего слоя необходим материал с низким удельным сопротивлением. В основном для создания токопроводящих дорожек используют вольфрам или молибден.
Рис.2. Методы редактирования цепей
Основные операции редактирования
Исходя из поставленных задач при редактировании цепей производятся следующие операции:
-
 High Aspect Ratio Milling, HAR - травление с высоким аспектным соотношением - осуществляется при необходимости редактирования на глубоких слоях. При хорошем сигнале детектора соотношение в зоне травления глубины к ширине может достигать 20 к 1 при использовании XeF2.
High Aspect Ratio Milling, HAR - травление с высоким аспектным соотношением - осуществляется при необходимости редактирования на глубоких слоях. При хорошем сигнале детектора соотношение в зоне травления глубины к ширине может достигать 20 к 1 при использовании XeF2.
-
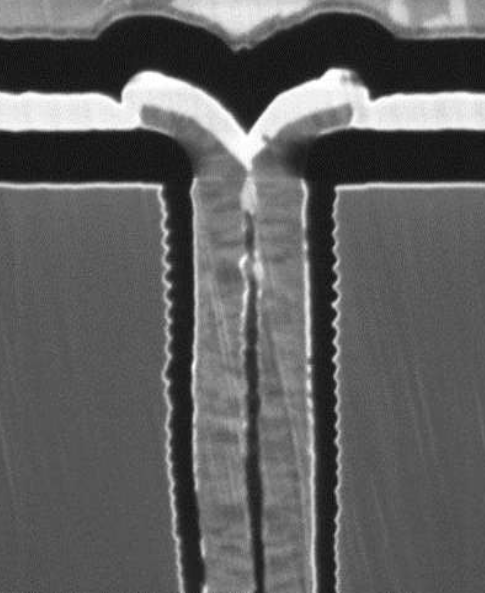 Vertical Interconnects - вертикальные межсоединения - требуются для создания контакта между проводниками. Для этого должны использоваться материалы с меньшим удельным сопротивлением. Чем у́же нужно сделать отверстие, тем ниже должен быть ток и сопротивление напыляемого материла.
Vertical Interconnects - вертикальные межсоединения - требуются для создания контакта между проводниками. Для этого должны использоваться материалы с меньшим удельным сопротивлением. Чем у́же нужно сделать отверстие, тем ниже должен быть ток и сопротивление напыляемого материла.
-
 Lateral Interconnects - поверхностные соединения - необходимы для соединения токопроводящих дорожек на верхнем или промежуточных слоях. При напылении, материал осаждается не только в нужной области, но и вокруг нее.
Lateral Interconnects - поверхностные соединения - необходимы для соединения токопроводящих дорожек на верхнем или промежуточных слоях. При напылении, материал осаждается не только в нужной области, но и вокруг нее.
-
 Over-spray Cleanup – чистка ионным пучком вокруг рабочей области.
Over-spray Cleanup – чистка ионным пучком вокруг рабочей области.
-
 Trace Cutting - резка токопроводящих дорожек - одна из самых распространенных операций при редактировании. Используется для удаления контакта между элементами микросхемы.
Trace Cutting - резка токопроводящих дорожек - одна из самых распространенных операций при редактировании. Используется для удаления контакта между элементами микросхемы.
-
 Часто появляется необходимость изменить глубоколежащий слой, до которого невозможно добраться, не задев верхние слои металлизации. Для этого используется операция реконструкции Reconstructive Surgery. Металлизация, которая преграждает путь к интересующей области, удаляется (если это не приведет к дополнительной неисправности) или перекоммутируется и после редактирования нужного слоя напыляется обратно.
Часто появляется необходимость изменить глубоколежащий слой, до которого невозможно добраться, не задев верхние слои металлизации. Для этого используется операция реконструкции Reconstructive Surgery. Металлизация, которая преграждает путь к интересующей области, удаляется (если это не приведет к дополнительной неисправности) или перекоммутируется и после редактирования нужного слоя напыляется обратно.
-
 Когда нужно отредактировать первый или второй слой металлизации на микросхеме с большим количеством слоев, иногда это проще сделать это с обратной стороны - Backside editing. Кристалл утоняется для более качественного обзора чрез ИК камеру (30-100 нм) и используются специальные режимы травления, чтобы быстро дойти до первого слоя, не повредив образец.
Когда нужно отредактировать первый или второй слой металлизации на микросхеме с большим количеством слоев, иногда это проще сделать это с обратной стороны - Backside editing. Кристалл утоняется для более качественного обзора чрез ИК камеру (30-100 нм) и используются специальные режимы травления, чтобы быстро дойти до первого слоя, не повредив образец.
-
 Небольшие уменьшения n-области N-well size reduction требуются для редактирования с обратной стороны и не влияют на работу микросхемы.
Небольшие уменьшения n-области N-well size reduction требуются для редактирования с обратной стороны и не влияют на работу микросхемы.
-
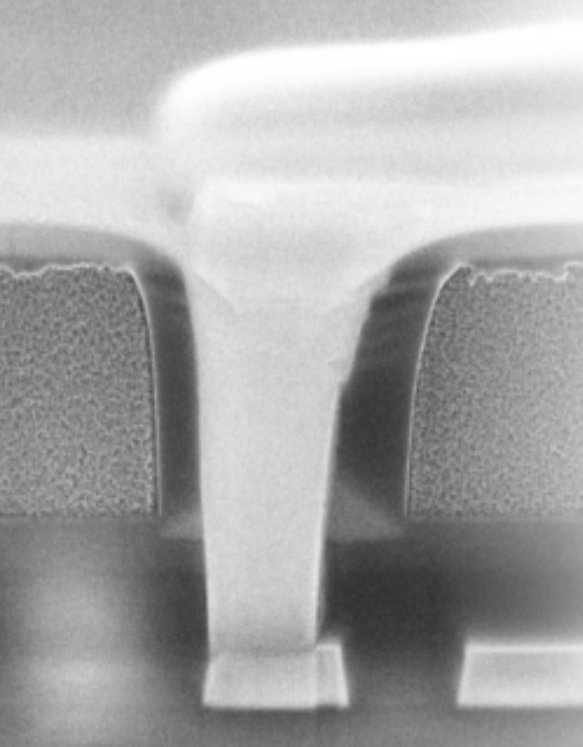 Чтобы снять электрические характеристики с интересующей области, которая может находится на нижних слоях, нужно вывести контактную площадку Probe-Point Creation, для этого проводится вертикальное соединение до верхнего слоя и напыляется небольшая область, на которую можно будет встать зондом.
Чтобы снять электрические характеристики с интересующей области, которая может находится на нижних слоях, нужно вывести контактную площадку Probe-Point Creation, для этого проводится вертикальное соединение до верхнего слоя и напыляется небольшая область, на которую можно будет встать зондом.
ВЫВОД
Многообразие классов и типов полупроводниковых устройств и совершенствование технологии их производства требует разработки новых принципов и методов диагностики их качества. Анализ отказов и редактирование цепей позволяют заменить длительные и дорогостоящие технологические отбраковочные испытания полупроводниковых устройств на более эффективные и экономичные. Особого внимания заслуживают комбинированные методы отбраковки дефектных изделий. Высокая эффективность редактирования цепей представленными методами подтверждена экспериментально.
Если Вам необходимо получить более подробную информацию о редактировании цепей, обращайтесь в нашу компанию. Наши специалисты расскажут подробно о методах редактирования и подберут для Вас соответствующее оборудование. Присылайте свои вопросы на электронную почту: info@sernia.ru.




