
Методы визуализации в просвечивающей электронной микроскопии
Просвечивающая электронная микроскопия (ПЭМ) - метод, который визуализирует образец с использованием электронного пучка. ПЭМ имеет лучшее пространственное разрешение (1-2 Å), чем СЭМ, но требует более сложной подготовки образца.
Просвечивающая электронная микроскопия является методом, который визуализирует образец с использованием электронного пучка (англ. TEM - Transmission electron microscopy). При просвечивающей микроскопии разрешение изображения составляет около 1-2 Å . Электроны высокой энергии (80 keV - 200 keV) передаются через электронно-прозрачные образцы (толщиной ~ 100 нм). ПЭМ имеет лучшее пространственное разрешение, чем СЭМ (англ, SEM - Scanning Electron Microscope), но требует более сложной подготовки образца.
Для достижения наилучших результатов в различных режимах работы ПЭМ предусмотрена возможность настройки и сохранения параметров линз, дефлекторных катушек (формирующих электронный пучок), разнообразных параметров электронного пучка и режимов формирования изображения.
Методами визуализации в просвечивающей электронной микроскопии (ПЭМ) являются: дифракционный контраст, фазовый контраст и сканирующая просвечивающая электронная микроскопия (СПЭМ).
Дифракционный контраст
Для ПЭМ дифракционный контраст единственный в своем роде метод, чувствительный к кристаллографическим изменениям фазы и толщины образца. Дифракционный контраст в изображении зависит от кристаллографической ориентации образца относительно электронного пучка. Это свойство обычно используется для определения границ различных компонентов полупроводниковых устройств и выявления дефектов, которые вводят в кристаллографическую фазу устройства изменения.
Дифракционный контраст позволяет визуализировать изменения в поликремнии, которые появляются в результате случайной кристаллографической ориентации зерен относительно падающего пучка. Наиболее характерные дефекты: дефекты в кремниевой подложке, стрингеры (вкрапления на границе металлов), блокировка контактов (рис.1 – 4).
Фазовый контраст
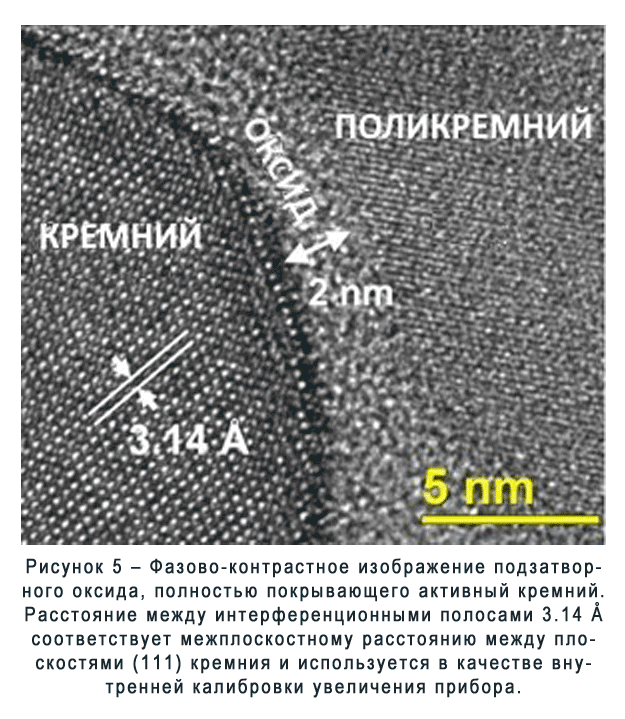
В исследованиях полупроводниковых устройств фазово-контрастные изображения высокого разрешения используются при измерениях толщины подзатворного оксида (рис. 5), метрологии субнанометровых деталей структур и идентификации тонких межфазных слоев, которые могут вызывать сбои устройств. Большинство современных ПЭМ оснащаются линзами высокого разрешения, характеризующимися разрешающей способностью менее 2,5 Å, в то же время, в более совершенных ПЭМ используются новые системы коррекции аберраций, позволяющие достигнуть разрешения менее 1Å.
Сканирующая просвечивающая электронная микроскопия (СПЭМ)
Когда электронный луч проходит через образец, происходит упругое (без потерь энергии) и неупругое (c потерями энергии) рассеивание электронов. Доля неупруго рассеянных электронов увеличивается с увеличением толщины образца. В режиме параллельной (одновременной) регистрации ПЭМ вклад неупруго рассеянных электронов негативно влияет на качество изображения, потому что возникают хроматические аберрации линз, используемых для увеличения объекта и формирования изображений. Сканирующая просвечивающая микроскопия (СПЭМ) менее восприимчива к таким хроматическим аберрациям, поскольку для формирования и увеличения изображений такие линзы не требуются. Это преимущество СПЭМ очень полезно для визуализации толстых (>200 нм) образцов, часто встречающихся при анализе отказов.
Метод с использованием электронов, рассеянных под большими углами (обычно более 50 мрад) называют STEM-HAADF-исследованием или методом кольцевого темного поля при больших углах, а также методом получения Z-контрастных изображений. Его часто используют для визуализации межфазных дефектов (рис. 6, 7).
Transmission electron microscopy
Увеличение просвечивающего микроскопа
В просвечивающей электронной микроскопии, ПЭМ (Transmission electron microscopy,ТЕМ) электроны ускоряются до 100 кэВ или выше (до 1 МэВ), фокусируются на тонкий образец (толщиной менее 200 нм) с помощью конденсорной линзовой системы и проходят через образец либо отклоняясь, либо не отклоняясь. Основными преимуществами ПЭМ являются высокое увеличение, в пределах от 50 до 106, и ее способность получать как изображение, так и дифракционную картину с одного и того же образца.
Рассеяние, претерпеваемое электронами во время прохождения через образец, определяет вид получаемой информации. Упругое рассеяние происходит без потерь энергии и позволяет наблюдать дифракционные картины. Неупругие столкновения между первичными электронами и электронами таких неоднородностей образца, как границы зерен, дислокации, частицы второй фазы, дефекты, вариации плотности и т.д., приводят к сложным процессам поглощения и рассеяния, которые ведут к пространственным вариациям интенсивности прошедших электронов. В ПЭМ можно переключаться из режима формирования изображения образца в режим регистрации дифракционной картины путем изменения напряженности поля электромагнитных линз.
Высокое увеличение или разрешение всех просвечивающих электронных микроскопов является результатом малой эффективной длины волны электрона X, которая задается соотношением де Бройля:

где m и q - масса и заряд электрона, h - постоянная Планка, а V - ускоряющая разность потенциалов.Например, электроны с энергией 100 кэВ характеризуются длиной волны 0,37 нм и способны эффективно проникать через слой кремния толщиной ˜0,6 мкм.
Разрешение просвечивающего микроскопа
Чем больше ускоряющее напряжение просвечивающего электронного микроскопа, тем выше его латеральное пространственное разрешение. Теоретический предел разрешения микроскопа пропорционален λ3/4. Просвечивающие электронные микроскопы с высоким ускоряющим напряжением (например, 400 кВ) имеют теоретический предел разрешения менее 0,2 нм. Высоковольтные просвечивающие электронные микроскопы обладают дополнительным преимуществом - большей глубиной проникновения электронов, так как высокоэнергетичные электроны слабее взаимодействуют с веществом, чем низкоэнергетичные электроны. Поэтому на высоковольтных просвечивающих электронных микроскопах можно работать с более толстыми образцами. Одним из недостатков ПЭМ является ограниченное разрешение по глубине. Информация о рассеянии электронов в ПЭМ-изображениях исходит из трехмерного образца, но проецируется на двухмерный детектор. Следовательно, информация о структуре, получаемая вдоль направления электронного пучка, взаимонакладывается на плоскости изображения. Хотя основной проблемой метода ПЭМ является подготовка образцов, она не столь актуальна для наноматериалов.
Дифракция от ограниченной области (SAD) предлагает уникальную возможность определения кристаллической структуры отдельных наноматериалов, например нанокристаллов и наностержней, и кристаллической структуры отдельных частей образца. При наблюдении дифракции от ограниченной области конденсорные линзы дефокусированы для создания параллельного пучка, падающего на образец, а для ограничения объема, участвующего в дифракции, используется апертура. Картины дифракции от ограниченной области часто используются для определения типа решеток Браве и параметров решеток кристаллических материалов по алгоритму, аналогичному используемому в РД [1]. Несмотря на то, что ПЭМ не способна различать атомы, электронное рассеяние исключительно чувствительно к материалу мишени, и для химического элементного анализа разработаны различные виды спектроскопии. К ним относятся энерго-дисперсионная рентгеновская спектроскопия (EDAX) и спектроскопия характеристических энергетических потерь электронов (EELS).
Просвечивающий электронный микроскоп и нанотехнологии
В нанотехнологии ПЭМ используется не только для диагностики структуры и химического анализа, но и для решения других задач. Среди них - определение температур плавления нанокристаллов, когда электронный луч используется для нагрева нанокристаллов, а точка плавления определяется по исчезновению электронной дифракционной картины. Другим примером является измерение механических и электрических параметров отдельных нанонитей и нанотрубок. Метод позволяет получить однозначную корреляцию между структурой и свойствами нанонитей.
Вывод
Просвечивающая электронная микроскопия (ПЭМ) незаменима для анализа твердых материалов. Сложное оснащение прибора позволяет провести исследования элементного состава и структуры кристаллической решетки образца. Пробоподготовка и продолжительный процесс исследования – делают данный метод исследования довольно трудоемким, но необходимым для разработки новых материалов, локализации и идентификации дефектов и отказов.
При подготовке статьи были использованы следующие материалы:
- 1. J. Ross “Microelectronics Failure Analysis Desc Reference. Sixth Edition” USA: «ASM International», 2011. – 660 стр.;
- 2. Д.Синдо, Т. Оикава «Аналитическая просвечивающая электронная микроскопия» Москва: «Техносфера», 2006. – 256 стр. ISBN 5-94836-064-4.
- Гочжун Цао Ин Ван, Наноструктуры и наноматериалы: синтез, свойства и применение – М.: Научный мир, 2012