Метод FIB - альтернатива механическому методу создания поперечных сечений
Появление ионно-лучевой микроскопии (англ. FIB, Focused Ion Beam), позволило качественно и быстро изготавливать поперечные сечения в микросхемах. Это значительно расширило возможности производителей современной электроники. Анализ изображений сечений дает возможность инженерам и соответствующим техническим специалистам оценить качество и основные характеристики изготавливаемого устройства, а также обнаружить скрытые малоразмерные дефекты, влияющие на работу ИС.
FIB является универсальным инструментом, позволяющим не только осуществлять финальную обработку изготовленных механическим способом поперечных сечений, но и создавать полноценные сечения «с нуля».
В последнем случае отсутствует необходимость механической обработки образца, так как сечение будет выполняться исключительно сфокусированным ионным пучком в системе FIB. На рисунках 1a и 2б представлены изображения поперечных сечений различных образцов, изготовленных с помощью FIB. Изображение на рисунке 1a получено путем сканирования образца ионным пучком, а изображение на рисунке 2б – путем сканирования электронным пучком.
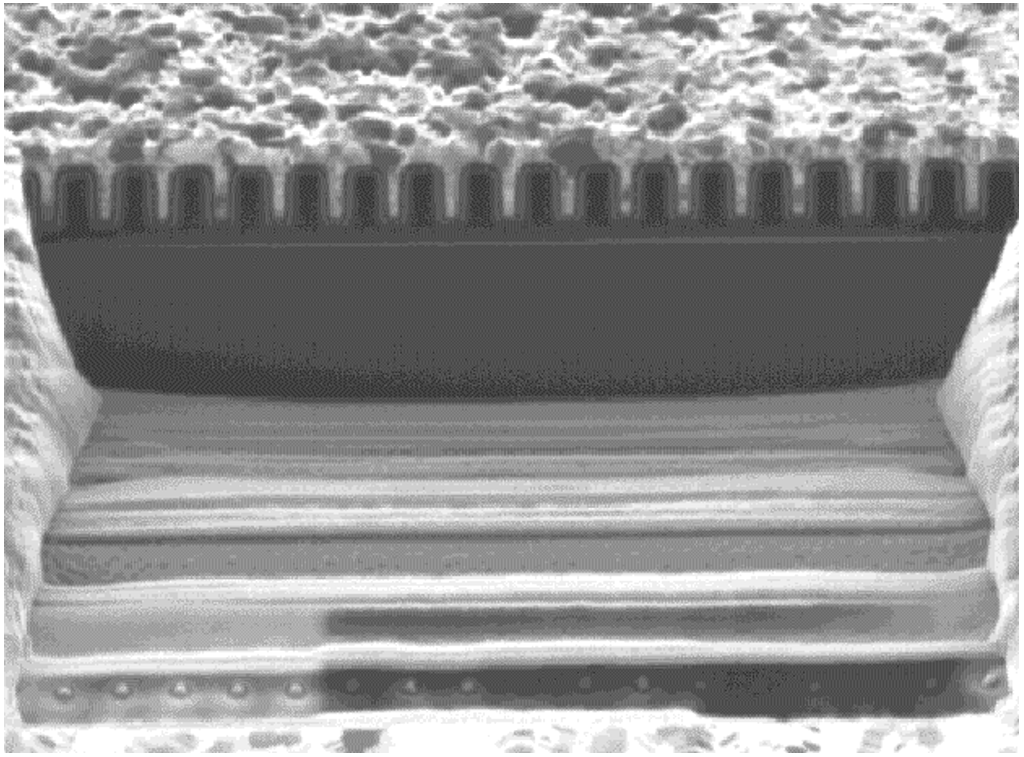
Рисунок 1а – Углубление, созданное в кристалле ИС с помощью FIB. На полученном изображении, регистрация которого осуществлялась путем сканирования ионным пучком, можно наблюдать поперечное сечение топологических объектов
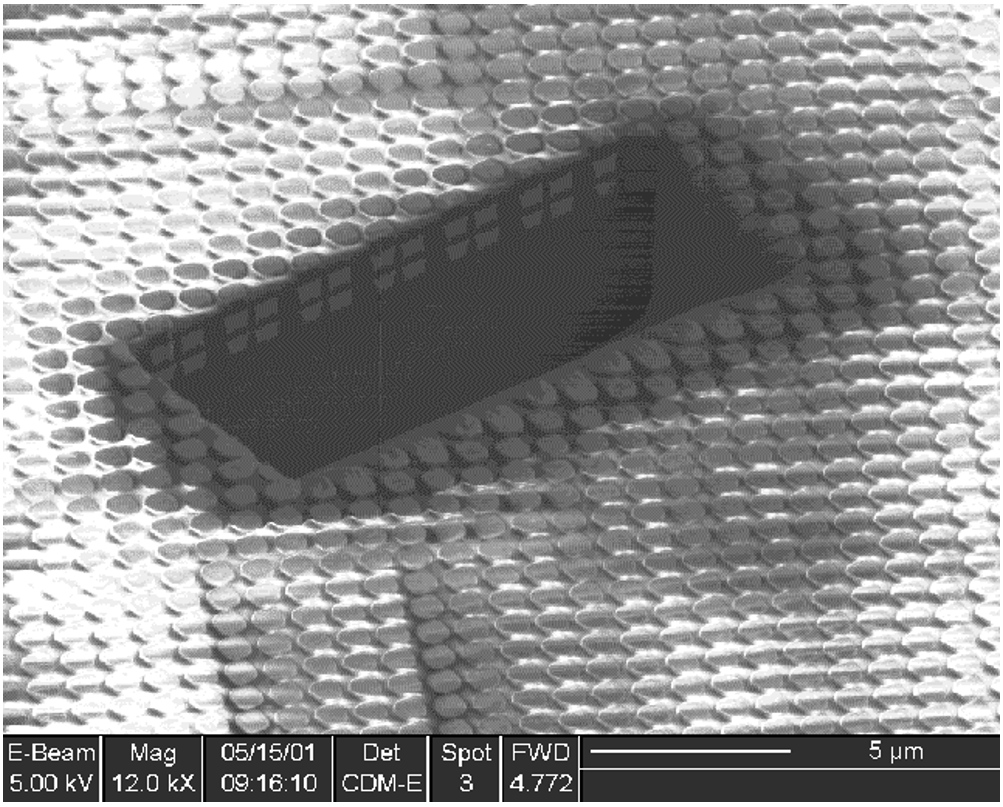
Рисунок 2б – Углубление, созданное в кристалле ИС с помощью FIB. На изображении, полученном сканированием образца электронным пучком под некоторым углом, можно наблюдать поперечное сечение топологических объектов
Как можно заметить из приведенных выше изображений, поперечное сечение располагается на одной из сторон созданного с помощью FIB углубления в кристалле ИС. Углубление создается т.н. методом «ступенчатого» травления, который состоит в том, что объем удаляемого материала зависит от глубины травления. В результате на стороне углубления, противоположной сечению, образуются ступеньки.
Такой метод обеспечивает высокую скорость удаления материала и позволяет избежать его переосаждения. Окончательный вид углубления в значительной степени зависит от используемой системы FIB и выбранной скорости травления. В любом случае, углубление должно быть достаточно большим, чтобы при наклоне образца ничего не препятствовало осмотру плоскости поперечного сечения.
Основные преимущества метода FIB
Существует несколько причин, по которым выбирают FIB в качестве единственного инструмента изготовления поперечного сечения: во-первых, это высокая скорость обработки образца, во-вторых - обеспечение высокоточной навигации по образцу.
Обнаружение местоположения дефектов ИС, как правило, происходит с помощью современной сканирующей электронной микроскопии с большим увеличением. При этом дефекты нередко располагаются под большими массивами однотипных элементов, которые сложно использовать в качестве ориентиров для навигации. Вдобавок, процесс создания поперечного сечения можно начинать сразу после обнаружения искомого участка, не затрачивая время на извлечение образца из рабочей камеры FIB и передачу его на обработку в другую систему.
Двулучевые системы предлагают расширенные возможности навигации по образцу из-за наличия в их составе электронной колонны, обеспечивающей долговременное сканирование без повреждения топологических структур, в отличие от сканирования ионным пучком.
Примеры поперечных сечений
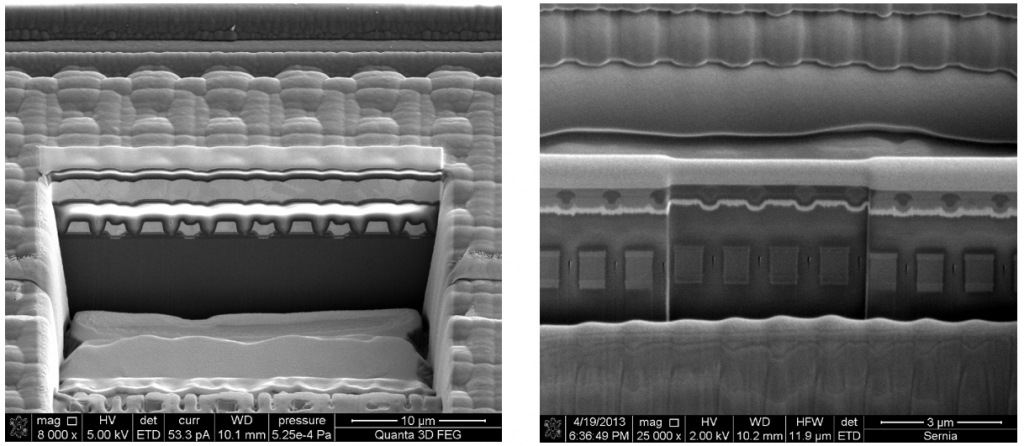
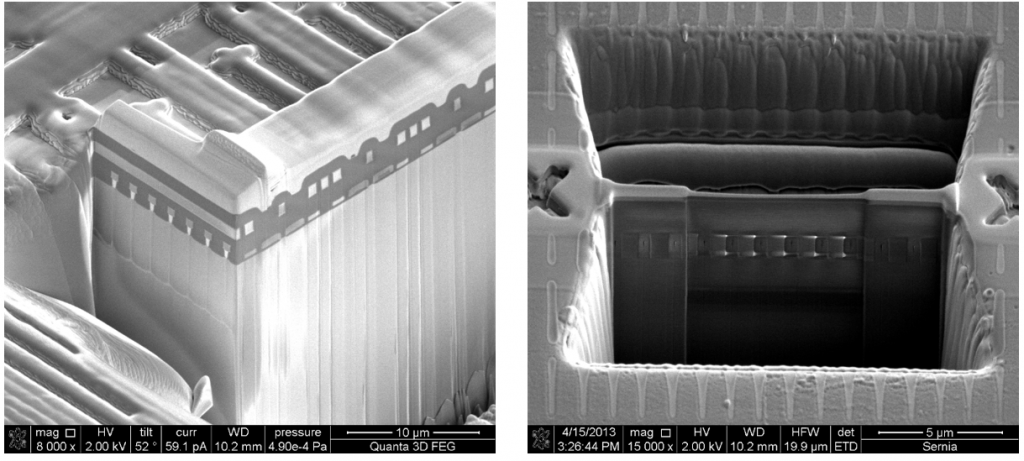
Выводы
-
FIB - чрезвычайно удобный и эффективный инструмент для создания поперечных сечений ИС. Существенными достоинствами FIB являются высокая точность подготовки сечений, полноценный контроль за процедурами ионно-лучевого травления, хорошая повторяемость и воспроизводимость операций.
-
Наиболее заметные результаты при использовании FIB достигаются в случае необходимости создания сечений отдельных структур с малыми геометрическими размерами. Такие сечения выполняются практически без артефактов и с минимальными временными затратами.
-
Также, было продемонстрировано, что применение FIB может значительно повысить качество поперечного сечения новых материалов, таких как low-k диэлектрики. Можно с уверенностью утверждать, что в ближайшем будущем FIB появится в каждой лаборатории, занимающейся анализом отказов, где станет незаменимым, постоянно задействованным в работе инструментом.
При подготовке статьи были использованы следующие материалы:
-
“Semicondactor Reliability Handbook” Renesas Electronics Rev 2.50 Jan 2017;
-
J. Ross “Microelectronics Failure Analysis Desc Reference. Sixth Edition” USA: ASM International, 2011 г. – 660 стр.