Электронно-лучевое тестирование (ЭЛТ) – это технология регистрации временных диаграмм изменения потенциалов, присутствующих на внутренних цепях интегральных схем, с помощью сфокусированного электронного пучка. Данная технология основана на физическом явлении потенциального контраста (Voltage Contrast, VC), о котором впервые сообщил Кен Смит из Кембриджского университета в своей докторской диссертации 1956 года. Он описал этот эффект как «зависимость средней интенсивности сигнала изображения во вторичных электронах от потенциала образца».
Принципы работы электронно-лучевого тестера
При нагреве до 1800К в сильном электрическом поле игла термополевого катода (TFE) начинает испускать электроны. Напряжение на катоде составляет -1 кВ относительно столика с исследуемым устройством, потенциал которого принят за ноль. Столь низкое ускоряющее напряжение выбрано с целью предотвратить повреждение исследуемого устройства и уменьшить зарядку его поверхности. Ускоряемые этой разностью потенциалов электроны фокусируется системой электромагнитных линз в узкий пучок с пятном диаметром 0.1 мкм, который падает на исследуемое устройство.
При ударе электронного пучка о поверхность исследуемого устройства, он проникает на глубину порядка 3 нм, и выбивает вторичные электроны, обладающие энергией от 0 до 50 эВ. Величина энергии определяется физическими свойствами материала устройства и величиной напряжения, под которой находится устройство.
Электрические и магнитные поля внутри объектива направляют вторичные электроны к сцинтиллятору, который преобразует их энергию во вспышки света, пропорциональные энергии электронов. Затем с помощью ФЭУ получается видеосигнал (с частотами порядка 5 МГц), который идет на дисплей. Чтобы получить картинку, электронный пучок отклоняется, сканируя поверхность образца по всем точкам.
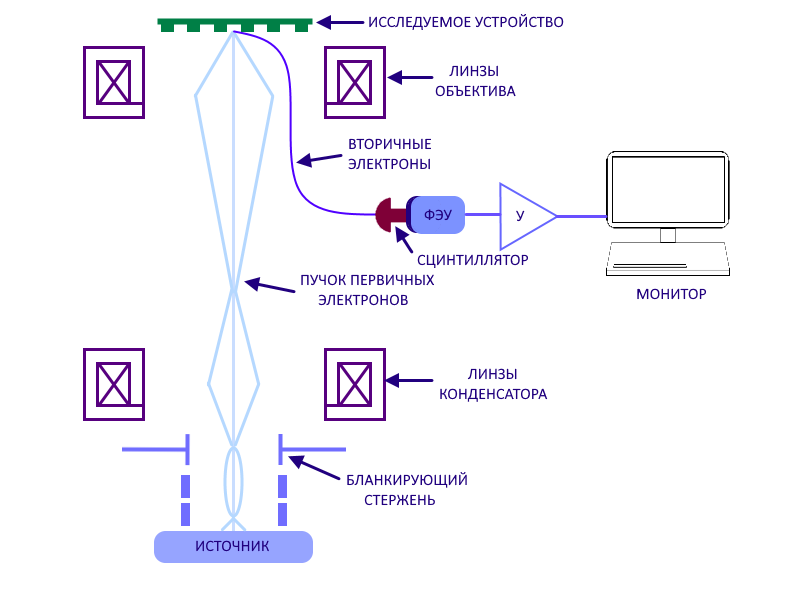
Рис.1. Основные компоненты электронной колонны
Пространственное разрешение электронной колонны микроскопа прежде всего зависит от размера сфокусированного электронного пятна, которое само зависит от множества факторов. При низком увеличении размер пикселя изображения гораздо больше размера пятна, поэтому именно размер пикселя будет определять оптическое разрешение. Электронная колонна оптимизирована для работы с ускоряющим напряжением 1 кВ, при котором максимальное разрешение составляет порядка нескольких десятых долей микрометра. Такое разрешение достигается за счет минимизации хроматических аббераций в объективной линзе.
Интенсивность полученного таким образом потенциально-контрастного изображения имеет нелинейную зависимость от напряжения на исследуемом образце. Чтобы получить реальные численные величины напряжения во всех точках, характеристику необходимо линеаризовать. На рис. 2 изображена упрощенная схема энергетического анализатора.
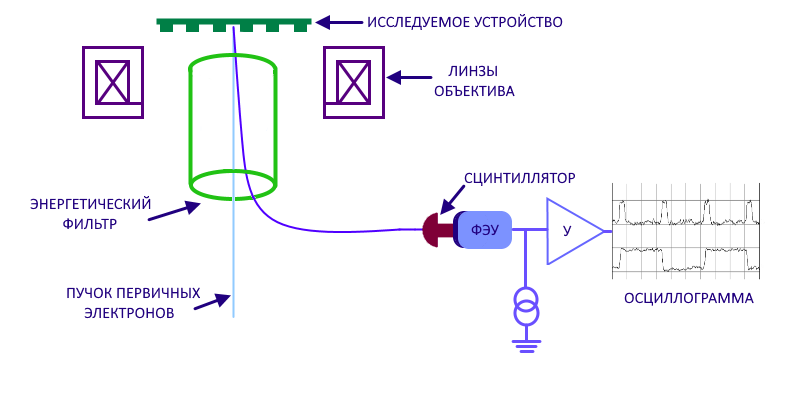
Рис. 2 Упрощенная схема энергетического анализатора
Энергетический фильтр расположен внутри объектива между исследуемым образцом и детектором вторичных электронов. При подаче на фильтр напряжения в нем образуется тормозящее поле, которое действует на вторичные электроны. Таким образом, для поступающих на детектор электронов возникает небольшой энергетический барьер. Если предположить, что работа выхода электронов с поверхности исследуемого образца не меняется со временем (например, отсутствует загрязнение), то число вторичных электронов, обладающих достаточной энергией, чтобы преодолеть потенциальный барьер, будет определяться только потенциалом поверхности образца.
Преимущества применения электронно-лучевого тестирования
Технология электронно-лучевого зондирования в дополнение к основным режимам потенциал-контрастной визуализации и измерения сигнала обеспечивает ряд дополнительных преимуществ:
- Методика не ограничена конкретной рассматриваемой технологией, поскольку её принцип основан на измерении потенциала поверхности образца
- Уникальная инвертированная конструкция электронной колонны позволяет беспрепятственно подключать аналитическое оборудование к исследуемым образцам
- Отличная чувствительность системы детектирования дает возможность регистрации качественных изображений потенциального контраста и обнаружения дефектов металлических проводников даже под слоем пассивации
- Низкая энергия первичного электронного пучка не оказывает разрушающего воздействия на тестируемый образец даже при длительном сборе данных
- Сканирующий электронный зонд не дает дополнительной емкостной нагрузки на исследуемую схему
- Возможно получить стробоскопическое изображение. Наблюдение за поведением устройства в определенном месте тестового вектора или же после определенной задержки на запускающий сигнал
Выводы

Методика потенциального контраста и основанная на ее базе технология ЭЛТ существуют уже почти 50 лет. Данная технология и ее ограничения хорошо изучены, коммерчески доступные установки ЭЛТ дают возможность осуществить отладку проекта и выполнить анализ неисправностей ИС. При ЭЛТ иногда возникает затруднение с доступом к цепям микросхемы с лицевой стороны, поэтому для анализа работы ИС и при определении характеристик сигналов часто используются специальные, предусмотренные на этапе изготовления ИС, тестовые площадки. Для обеспечения доступа к нижним слоям ИС при подготовке образца к ЭЛТ в целях анализа отказов в настоящее время повсеместно применяются FIB.
На рисунке видно, что на контактной площадке темного цвета присутствует незапланированный высокий уровень (предположительно, имеет место короткое замыкание).
При подготовке статьи были использованы следующие материалы:
-
J. Ross “Microelectronics Failure Analysis Desc Reference. Sixth Edition” USA: «ASM International», 2011. – 660 стр.;
-
John T.L. Thong “Electron Beam Testing Technology” England: “Springer Science + Business Media, LLC”, 1993 – 462 стр.
