Статья посвящена механизму отказов электронных устройств. Будет полезна технологам на предприятиях, производящих микроэлектронные устройства.
В данной статье представлены наиболее распространенные отказы полупроводниковых устройств.
Механизмы отказа
Тесты на надежность предназначены для воспроизведения отказов изделия, которые могут возникнуть при последующем использовании. Результаты тестов на надёжность способствуют пониманию механизмов отказов. В случае возникновения отказа знание его механизма поможет выявить вызвавший его фактор (температура, влажность, напряжение, ток и т.д.).
Надёжность изделия при последующей эксплуатации может быть спрогнозирована на основании результатов тестов на надёжность, проведённых в ускоренных условиях (при повышенных нагрузках). Недостатки, влияющие на надёжность изделия, могут быть определены при более детальном изучении механизмов отказов.
Тестирование надёжности предоставляет полезную информацию также и для производителя, стремящегося защитить продукцию оптимальным способом, выбор которого зависит от обнаруженных отказов.
Классификация отказов
Для анализа надёжности полупроводниковых устройств используются статистические методы и методы устранения отказа, основанные на понимании физических основ процесса. Такой подход называется физикой отказа. Его цель – прояснить механизмы отказов, формируя понимание их физических характеристик на атомном и молекулярном уровнях.
Режимы отказов полупроводниковых устройств, как правило, подразделяются на разрывы цепей, короткие замыкания, деградацию и пр. Взаимосвязь между этими режимами отказов и их механизмами подробно описаны в таблице 1.
Таблица 1 Факторы отказа, механизмы и режимы
|
Факторы отказа |
Механизмы отказа |
Режимы отказа |
Пример |
|
|
Область p-n-перехода |
- Подложка. |
- Дефект кристалла. |
- Пониженное напряжение пробоя. |
|
|
Оксидная плёнка |
- Подзатворная оксидная плёнка. |
- Ионная подвижность. |
- Пониженное напряжение пробоя. |
Рис.1 |
|
Металлизация |
- Внутренние цепи. |
- Царапина или пустая полость. |
- Разрыв цепи. |
Рис.2 |
|
Пассивация |
- Поверхностная защитная пленка. |
- Прокол или трещина. |
- Пониженное напряжение пробоя.
- Ухудшение шумовых характеристик. |
|
|
Соединение кристалла с корпусом |
- Соединения с рамкой микросхемы. |
- Отрыв образца. |
- Разрыв цепи. |
Рис.3 |
|
Провода, соединяющие выводы кристалла и корпуса |
- Связь провода с кристаллом. |
- Смещение подсоединенного провода. |
- Разрыв цепи. |
Рис.4 |
|
Герметизация |
- Смола. |
- Пустота. |
- Разрыв цепи. |
Рис.6,7 |
|
Площадка ввода/ вывода |
- Статическое электричество. |
- Пробой p-n-перехода. |
- Разрыв цепи. |
Рис.9 |
|
Иные |
- Альфа-частицы. |
- Генерация электронно-дырочных пар.
|
- Программный сбой.
|
|

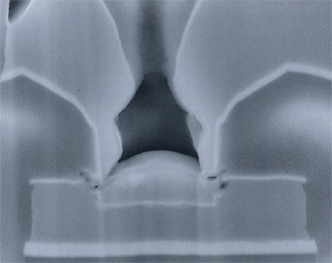
*При подготовке статьи были использованы следующие материалы:
- “Semicondactor Reliability Handbook” Renesas Electronics Rev 2.50 Jan 2017;
- J. Ross “Microelectronics Failure Analysis Desc Reference. Sixth Edition” USA: ASM International, 2011. – 660 стр.