Система ФИП - это эффективное сочетание сканирующего ионного микроскопа и инструмента для прецизионной обработки материала. ФИП был разработан в результате исследований Крона в 1961 году, посвященным жидкометаллическим источникам ионов (ЖМИИ) для использования в космосе. Разрабатывая двигатель, использующий заряженные металлические капли, он первые опубликовал данные об эмиссии ионов из жидкометаллического источника. ЖМИИ стали применяться для полупроводников и в материаловедении. Промышленное внедрение ФИП произошло в 1980-х годах, преимущественно для растущей полупроводниковой промышленности, но также найдя нишу и в материаловедении.
Современные системы ФИП для генерации ионов, обычно Ga+, используют ЖМИИ в верхней части колонны. Отсюда ионы выстреливаются, затем фокусируются в пучок электрическим полем и последовательно проходят через апертуры, затем сканируют поверхность образца (Рис. 3). В зависимости от силы, столкновения ионов с атомами могут иметь упругий или неупругий характер. Упругие столкновения приводят к отрыву поверхностных атомов - так называемое «распыление» - и являются основной причиной модификации поверхности материала (Рис. 4). Неупругие столкновения случаются, когда ионы передают часть своей энергии поверхностным атомам или электронам. В результате появляются вторичные электроны (электроны, которые были возбуждены и смогли уйти со своей оболочки) наряду с рентгеновскими лучами (энергия высвобождается, когда электрон возвращается на более низкую орбиту). Вторичные ионы также генерируются в процессе столкновений, по-видимому, после эмиссии вторичных электронов.
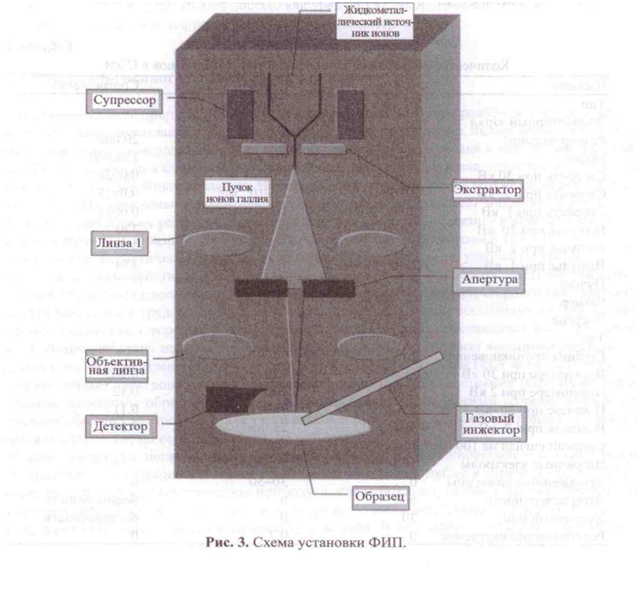
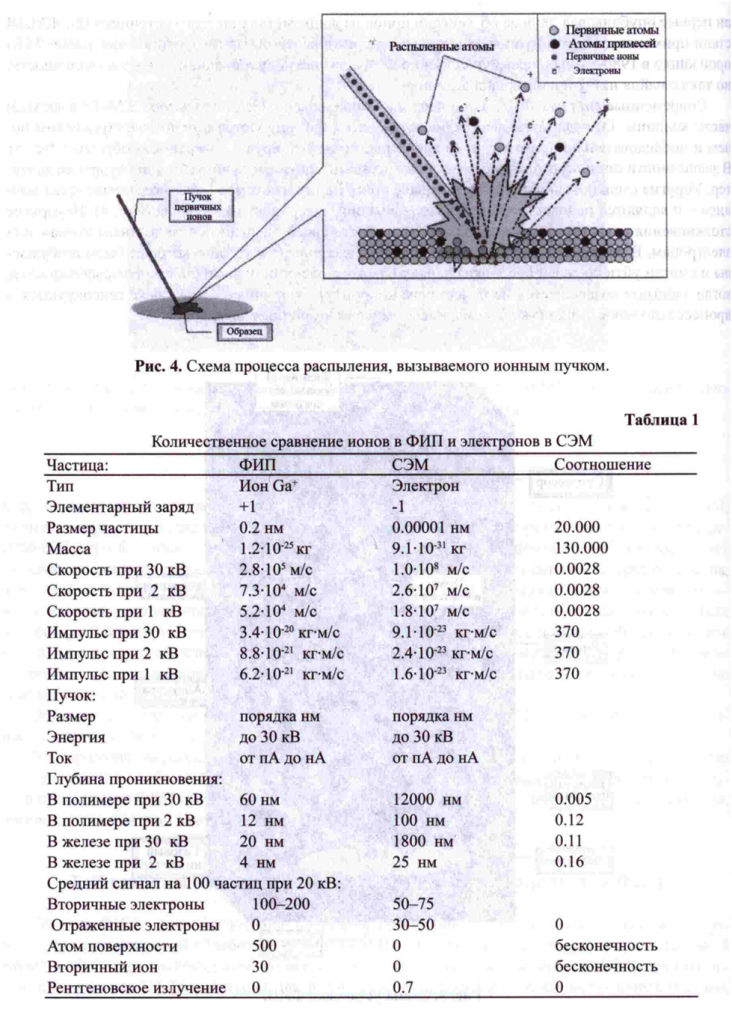
Полезная информация может быть получена от всех видов эмиссии, в зависимости от оснащенности установки. Сигналы от испущенных ионов после детектирования могут быть усилены и отображены, и в результате мы получим детальное изображение структуры поверхности образца. Помимо возможности визуализации, ФИП может быть использован в качестве инструмента по осаждению материалов посредством впрыска металлорганического газа на пути распространения ионного пучка непосредственно вблизи поверхности образца. Эта методика применяется для восстановления некоторых материалов. Вдобавок, при удерживании ионного пучка на определенном участке образца в течение продолжительного времени непрерывный процесс распыления приведет к заметному удалению части материала, что применяется для зондирования и обработки.
Физической основой работы ФИП является то, что ионы значительно тяжелее электронов (Табл. 1). Столкновения крупных первичных ионов с атомами поверхности вызывают ее модифицирование, зависящее от дозировки, перекрытия, выдержки и многих других переменных, которое не может быть достигнуто с помощью электронов .
Установка ФИП предоставляет уникальную возможность выбрать определенный участок образца, так чтобы модифицировать только его, не затрагивая весь остальной образец. Эта особенность имеет широкую область применений, от простых техник (формирование отверстий для анализа) до более сложных (прецизионное вырезание трехмерного поперечного сечения образца).
Вдобавок, ФИП, обладая возможностью как травления, так и осаждения, является идеальным инструментом для анализа дефектов и восстановления материалов.
Нан Яо, Чжун Лин Ван, Справочник по микроскопии для нанотехнологии - М.: Научный мир, 2011, стр.256-259
